一. 消息面汇总
为缓解CoWoS先进封装产能吃紧问题,英伟达正规划将其GB200提早导入扇出面板级封装(FOPLP),从原订2026年提前到2025年。
当前全球先进封装最受瞩目的是CoWoS技术,英伟达的H100、A100由台积电代工,并使用台积电CoWoS技术;
AMD MI300也导入CoWoS技术,造成CoWoS全球产能供不应求。
整体来看,在CoWoS产能不足情况下,FOPLP有望成为纾解AI芯片供应问题的利器。
当前FOPLP技术指标弱于台积电的CoWoS,但其潜在优势是容纳更多的IO数、成本更低、存在产能突破瓶破的可能性。

二. 先进封装技术概览
半导体制造业可分为芯片设计、晶圆制造、封装测试三大环节;封装是将晶圆进行切割、焊线,使芯片电路与外部器件实现连接。
随着台积电2nm工艺实现突破,芯片制程已接近物理尺寸极限,通过先进封装对芯片进行封装级重构,从而提升芯片性能成为了新发展趋势。
先进封装就是将原来需要一次性流片的大芯片,改为制造若干颗小面积芯片,然后通过先进封装工艺,将这些芯粒组装成大芯片。
先进封装技术包括:倒装(FlipChip)、凸块(Bumping)、硅通孔(TSV)、晶圆级封装(WLP)、2.5D、3D等。
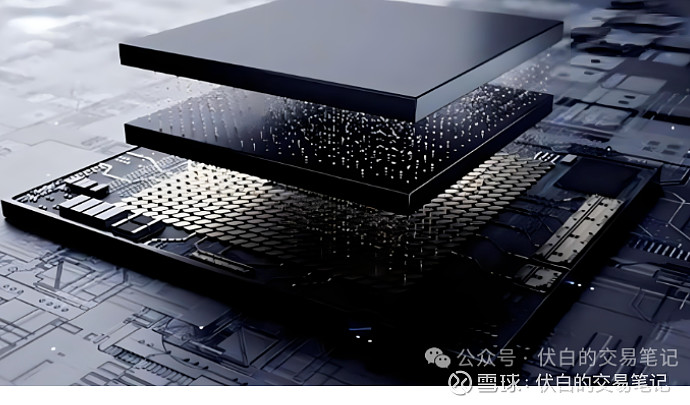
三. FOPLP概览
扇出面板级封装(FOPLP)是扇出晶圆级封装(FOWLP)的延伸,是在多晶粒集成需求、降低生产成本的考量下,所衍生出的封装技术。
FOPLP是基于重新布线层(RDL)工艺,将芯片分布在大面板上进行互连的先进封装技术,能够将多个芯片、无源元件和互连集成在一个封装内。
FOPLP主要特征:
(1)与传统封装方法相比,提供了更大的灵活性、可扩展性。
(2)效能提升且降低成本:FOPLP面积使用率大于95%,有效减少浪费;同时能够在一次封装过程中处理更多的芯片,从而形成规模效应,具有成本优势。
目前FOPLP面临的制约因素还有不少:
(1)涵盖了多种设备及工艺难点,面临精度、效率和速度等多重挑战。
(2)良率有待提升:当前FOPLP良率不及FOWLP,提高良率也是其发展重点。
四. FOPLP产业进程
全球方面,三星是FOPLP技术绝对的引领者。
在2018年,三星在其Galaxy手表上采用了扇出型面板级封装APE-PMIC,这是FOPLP的全球首次量产。
日月光也是最早布局FOPLP技术的厂商,其于2019年完成产线建置,2020年量产,应用于RF、FEM、Power和Server领域。
但总体来说,目前FOPLP产业的发展尚处于早期阶段,受到良率、供应链不完善、设备研发、标准化问题、散热等多重挑战。

五. 国内厂商梳理
曼恩斯特:涂布整体技术解决方案供应商。在半导体先进封装领域,公司涂布技术应用于面板级的扇出型封装涂布工序。
深南电路:国内PCB、封装基板领先企业,子公司天芯互联面向先进封装领域,依托系统级封装 (SiP)、板级扇出封装 (FOPLP)。
华海诚科:半导体封装材料供应商,公司可供应应用于QFN/BGA、FC、SiP、FOWLP、FOPLP等封装形式的封装材料。
易天股份:平板显示及半导体设备供应商,公司控股子公司微组半导体部分设备可应用于SIP、FOWLP等先进封装。
劲拓股份:电子整机装联设备、光电平板显示模组生产设备等设备生产商,公司芯片封装热处理设备可应用于FOPLP的倒装芯片焊接工艺。