集微网报道(文/林美炳)得先进封装着得天下俨然已成通往后摩尔时代王座的“通行证”,群雄正纷至沓来。
随着摩尔定律放缓,封装工艺的重要性愈发凸显,成为全球芯片产业关注的焦点。不仅传统芯片封装厂、晶圆代工厂斥巨资攻关技术,面板厂商也跨界涌入,成为面板级芯片封装(PLP,Panel Level Package)领域的一股新势力。
面板厂商布局面板级封装的初心本是为其旧产线谋出路,同时进军不断成长的封装领域拓展新业务,但这条路可谓雄关漫道,精度、良率、制程、客户等问题都成为重重挑战。
竞逐“后摩尔时代”技术高地,屏厂的这波冲“封”,能有几成胜算?
屏厂扎堆 面板级芯片封装受追捧
面板级封装与晶圆级封装不同,主要采用PCB、玻璃基板等方形载板,可使用的封装面积增大,在相同的良率下,具有生产效率高,生产成本低,适于大规模生产的优势,成为备受关注的芯片封装技术之一。
当前,高世代液晶面板生产线还在不断新建,5代以下的低世代液晶面板生产线在行业下行周期中遭淘汰的风险正在不断提高。五年前,京东方、天马、群创、友达、TCL华星光电等液晶面板厂商陆续涉足面板级芯片封装领域,试图将低世代液晶面板产线改造为有部分类似制程的面板级芯片封装产线,开辟全新赛道。
国内面板龙头京东方率先开启在这一领域的探索。早2017年,京东方就通过芯动能入股封装测试企业颀中封测,后又注资封装检测设备厂商中科飞测,并在北京5代液晶面板产线上进行面板级芯片封装工艺和技术研发。年初又有消息传出,京东方与华为在面板级芯片封装领域开展合作。
深天马拥有多条低世代液晶面板产线,急于转型,自2018年以来一直高度关注面板级芯片封装技术的进展,并在成都4.5代线开发相关工艺和技术。2022年7月,深天马全资子公司湖北长江新型显示产业创新中心有限公司与通富微电共同成立上海富天沣微电子有限公司,加速推进面板级先进芯片封装技术突破。
友达、群创也将面板级封装作为一条新出路。2019年群创开始与台湾工研院、嵩展、纮泰、新应材等合作研发面板级扇出型芯片封装技术,将3.5代液晶面板产线改造成面板级芯片封装生产线。今年6月,群创正式进军“面板级扇出型封装”领域。友达进度不如群创,也在测试面板级封装的制程。
TCL华星光电没有旧线改造的需求,但是面板级芯片封装是新机会。据了解,TCL华星光电已购买相关设备,开展相关研究。
液晶面板厂商涉足面板级芯片封装领域引起玻璃基板配套厂商的高度关注。康宁和旭硝子等正在研发用于先进芯片封装的玻璃载板。康宁称正在为客户提供用于先进制程的高精度玻璃载板,目前已向高阶客户出货超过50万片。
四大阵营 面板级芯片封装正突围
面板级芯片封装对于面板行业来说可能是新事物,但是对于传统封装行业来说只是一个工艺方向,很早就已经在讨论面板级芯片封装技术。亚智科技销售副总经理简伟铨表示,十年前,矽品科技就与设备厂商合作开发面板级芯片封装工艺,亚智科技也开始进行相关设备的研发。
但是率先打通面板级芯片封装工艺制程的是三星。据了解,三星因为封装技术问题在2015年被台积电抢去苹果部分A9芯片订单,到2016年台积电凭借扇出型封装技术(InFO FOWLP)开始独占苹果A10芯片订单。痛失苹果A系列订单之后,三星开始重视封装技术,希望通过面板级扇出型封装(FOPLP)实现追赶甚至超车。
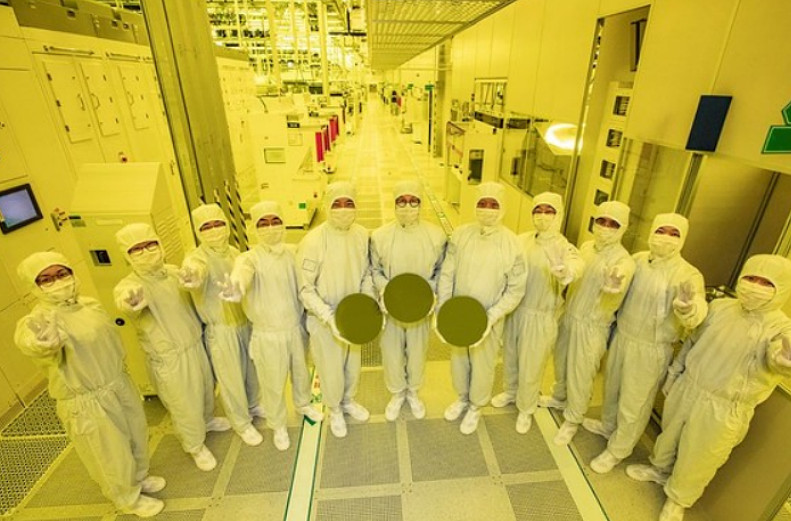
从2015年开始,三星电机与设备厂商合作开发FOPLP;2016年,专门成立FOPLP部门,打通工艺制程路线,搭建510x415mm尺寸的FOPLP生产线,并于2018年用该技术首次将Galaxy Watch的PMIC、DRAM以及AP集成在一起。2019年,三星电子收购三星电机FOPLP业务,加大研发投入,加快FOPLP技术突破,试图凭借FOPLP重新争取苹果A系列芯片,但至今未获成功。
与此同时,日月光、力成科技、成都奕斯伟、英特尔、纳沛斯、华润微等其他厂商也在积极推进PLP。据集微网了解,力成科技2017年就开始投入PLP研发,于2018年用PLP封装联发科电源管理芯片(PMIC);日月光于2019年也获得海思PMIC FOPLP订单,2020年成功研发出扇出型动态补偿光罩之面板级封装技术,2020年下半年FOPLP实现量产,并向射频、射频前端模组、电源服务器市场拓展。成都奕斯伟从2017年开始研发PLP技术,与设备厂商三年联合攻关打通了工艺制程,计划明年投产,主攻消费电子、HPC类芯片封装。
于是,PLP领域形成了晶圆厂、传统封装厂、载板厂、面板厂等四股力量。在简伟铨看来,晶圆厂如果跟随台积电InFO封装工艺路径难以赶超,传统封装厂缺乏晶圆厂和芯片设计业务,无力推进InFO封装技术,而FOPLP提供换道超车的机会,成为晶圆厂、传统封装厂的重要选择。载板厂原本只是向封装厂提供载板,如果研发FOPLP工艺,就有机会向封装厂供应镀完膜的RDL(Re-distributed layer,重布线层),提高产品附加值。
旧线转型 屏厂探索板级封装出路
与封装厂、载板厂不同,液晶面板厂商涌入面板级芯片封装领域主要是为低世代液晶面板产线寻找出路。当前,液晶面板行业处于下行周期,大量缺乏竞争力的低世代液晶面板产线遭淘汰的风险提高,面板厂商正在为其寻找转型方向。
集微咨询分析师王永攀表示,液晶面板制造过程与芯片封装过程有相通之处,液晶面板制造过程中的Array制程与芯片封装制程极为相似,特别与面板级芯片封装有较强的交合点。
“三星显示器公司退出液晶面板市场之后,将300多人的液晶面板业务员工转到芯片封装业务,进一步表明液晶面板制程与芯片封装制程有一定相通性。”王永攀说。
群创总经理杨柱祥表示,群创将旧世代3.5代面板产线转作成面板级扇出型芯片封装应用,除提升产线利用率,就资本支出而言更具优势,未来更可切入中高阶封装产品(应用处理器AP、CPU、GPU)供应链,抢攻封装厂订单,以创新技术创造高价值。
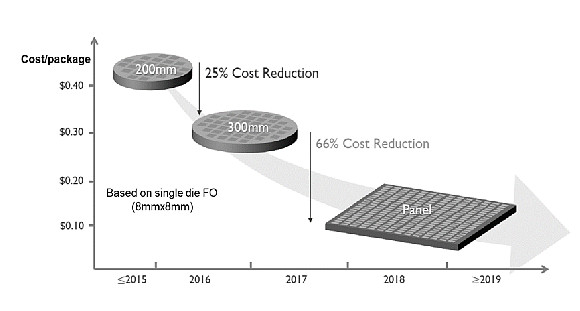
此外,面板级芯片封装技术具有成本和效率优势。半导体封装技术专家李扬告诉集微网,目前,面板级封装采用如 24×18英寸(610×457mm)的PCB或者玻璃载板,其面积大约是 300 mm硅晶圆的4倍,在相同的良率下可以量产出4倍于300mm硅晶圆的先进封装产品。由于面板的大尺寸和更高的载具使用率(95%),带来了远高于晶圆级封装的规模经济效益。与晶圆级封装相比,面板级封装技术优势在于生产成本低、生产效率高。
杨柱祥也指出,3.5代液晶面板的基板面积为12英寸晶圆的六倍,面积利用率可由晶圆级的85%提升至95%,提供5G及AIoT发展下先进元件封装需求,产业应用价值可提升十倍,估计量产后衍生半导体封装产值达140亿元新台币(约31.78亿元人民币)以上。
面板级芯片封装工艺线宽、线距方面可以做得更加精细,热性能、电气性能表现更优。简伟铨表示,传统晶圆级芯片封装用WireBond或者QFN方式打线,存在一定散热问题,电性表现不足。但玻璃载板的面板级封装线宽精度更高,既可以做15微米以上的线宽,也可以做15微米到5微米的线宽,甚至5微米以下,改善芯片热性能、电气性能。例如,三星电机通过应用FOPLP,可以将Galaxy Watch的AP封装的厚度减少20%以上,从而提高了电气和热性能,并有助于扩大产品的电池容量。因此,面板级封装有可能部分取代传统晶圆级封装以及晶圆级扇出型封装的市场。
当然,面板级封装也可以胜任异构集成。简伟铨表示,随着摩尔定律的放缓,异构集成成为延续摩尔定律的重要方向,玻璃载板、面板级芯片封装工艺特性也适合异构集成,在IoT、AI、5G、汽车和服务器等芯片封装市场大有可为。
困难重重 屏厂跨界封装胜算几何?
面板级芯片封装市场前景广阔,呈现高速成长的态势。根据Yole报告,2018年至2023年,FOPLP的年复合成长率(CAGR)将可望达到70%以上,预计2023年FOPLP销售额将达到2.793亿美元。但广阔的机遇下,面板厂商进军面板级封装也面临精度、良率、制程、客户等方面的挑战。
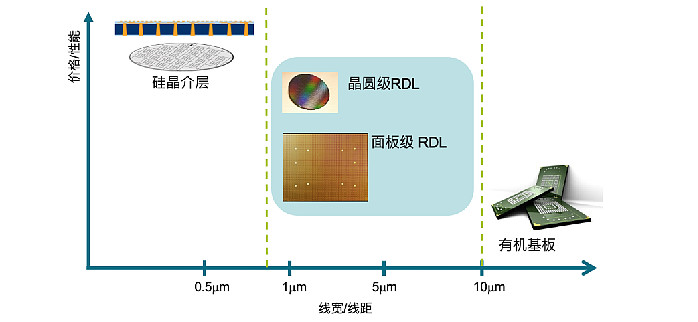
面板级封装采用PCB技术,目前精度还达不到晶圆级封装的水平,提高生产精度是其面临的主要挑战。李扬表示,为了提高生产精度和良率,对面板的平整度,以及面板对RDL工艺和材料的兼容性都有一定的要求,所以可能需要重建RDL技术和工艺。
面板级封装尺寸更大,但是目前良率不高。Omdia显示部门研究总经理谢勤益告诉集微网,3.5代或者4.5代玻璃基板尺寸比12英寸晶圆封装面积大很多,良率却不如晶圆级封装技术,所以提高良率也是面板级封装工艺的重点。
FOPLP缺乏统一标准,载板尺寸、设备开发、制程整合、材料等都需要订制化,提高了进入门槛。液晶面板产线部分湿法设备、自动化设备可以用于面板级封装产线,但是由于两者的工艺差异太大,需要面板厂商与设备厂商合作进行大量有针对性的改造,如果工艺制程路线没有确定,设备也没法改造。例如,如果产品需求线宽是25微米,不一定用得上液晶面板用的曝光机,有可能成为包袱,而且还存在面板翘曲、芯片位移、裸片对位精准度等问题。
简伟铨指出,液晶面板产线改造还需要增加电镀设备,但是目前在2.5代玻璃基板上电镀的均匀度无法达到10%,在3.5代、4.5代玻璃基板上电镀的可行性还需要进一步验证。
液晶面板产线通过改造转为面板级封装产线难度很高。一位面板级封装行业人士向集微网透露,其公司原本计划将4.5代液晶面板产线改造成面板级封装产线,最终发现只有20%-30%的液晶产线设备可以利用,而且设备需要大改,最终不得不放弃,选择新建一条面板级封装产线。
其实,对于面板厂商来说,涉足面板级封装领域最大的挑战可能是出海口。
简伟铨指出,面板级封装市场与面板商业模式不一样,面板有标准品,但是封装技术无法统一,不同的厂商需求也不一样,面板厂商如果没有找到合适的半导体供应链策略合作伙伴,或者内部自主消化产能,商业模式难以成型。
当然,从降低风险考虑,面板厂商可能更愿意先切入RDL First,然后供应给封装厂商,但是Chip First才有更大的市场机遇,所以面板厂商还需要弥补封装技术、人才、客户的不足,才有机会与传统晶圆级封装厂商竞争。
王永攀指出,在商业模式难以成型,目标产品无从下手的现状局面下,或许面板厂可以思考一下利用PLP来满足自用芯片封测的需求,以实现中国大陆面板用芯片从设计、制造到封测端的产业完全自主。
多位行业人士表示,面板厂商涉足面板级封装不仅可以盘活低世代液晶面板产线部分设备,充分利用现有的研发人员,还有机会进军不断成长的芯片封装领域,拓展新的业务,几乎所有的主流面板厂商纷纷涌入面板级芯片封装领域。但面板厂商在半导体产业链缺乏足够的积累,靠孤军奋战面临重重关卡,只有整合更多的半导体产业链资源,才有可能像三星一样在两三年左右打通技术和商业壁垒,闯出自己的一片天。(校对/张轶群)