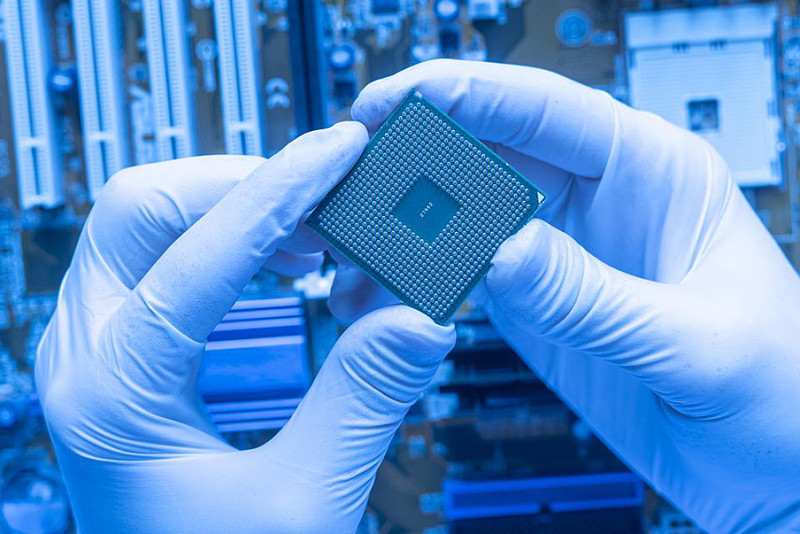
图片来源:Forbes
集微网消息(文/思坦),据业内人士透露,随着越来越多支持毫米波和HPC的芯片设计出现,在商业化应用增长的驱动下,AiP、3D堆叠以及其他先进封装技术的需求将进一步提高。
《电子时报》援引上述人士称,一款毫米波智能手机需要2-3个AiP模块,这使得日月光凭借其FC-AiP技术显著受益,并补充称,该公司目前是毫米波天线封装、测量和微波暗室技术的领导者。
根据此前报道,苹果将在2021年大幅提高5G毫米波iPhone机型的发货量,占比将达到50%。日月光及其子公司矽品科技(SPIL),以及环旭电子(USI)预计将获得AiP模块的大订单。
不过,日月光不会是众多厂商的唯一选择。在台积电一系列基于3D Fabric平台的晶圆级InFO技术中,InFO_AiP是客户的另一个选择,其优势在于能够减少基板的使用,并支持更薄的IC设计,但成本高于FC-AiP。
AMD在其新推出的3D小芯片处理器中就采用了台积电的3D硅堆叠和先进的封装技术,业内人士预计这将推动越来越多的台积电客户尝试其最新的SoIC 3D 堆叠技术以及其他先进封装技术。
(校对/小山)