
当代,全球先进封装市场的竞争选手包括了IDM(半导体垂直整合制造商)、Foundry(晶圆代工厂)以及委外封测服务(Outsourced Semiconductor Assembly and Test,简称OSAT)供应商等,主要头部玩家包括日月光、安靠、长电科技、台积电、三星及英特尔,6家大厂合计占据整个先进封装市场近80%市场份额。
近些年随着先进封装的迅速发展,我们可以明显观察到,传统封测厂在市场竞争中逐渐处于一定的落后位置,而以高端先进封装技术为代表的如台积电逐渐逼近市场首位。随着摩尔定律发展受限,先进封装技术也愈发受到重视。据行业数据统计显示,2022年先进封装在整体封装市场的占比已经接近三成,而至今年,占比已近4成,且先进封装增速高于整体封装。
先进封装市场过于庞大,以台积电、日月光为首的企业在竞争中相互合作,互相成就,先进封装领域呈现新的图景。本文将通过观望日月光和台积电两家大企的成长一窥先进封装发展趋势。
老牌封测龙头日月光厚积薄发
精进先进封装技术
日月光投控一贯坚持的路线都很清晰明确,通过持续的并购与扩产,拥有多样化的封装技术和庞大产能,建立包括芯片前段测试及晶圆针测至后段之封装、材料及成品测试的一体化半导体封装及测试中心服务客户。并在当代,与时俱进发展先进封装,持续强化集团在全球营运布局,继续壮大封装帝国版图。
1、再建新厂,全球化步伐迈进
近日,日月光投控继续扩产,旗下日月光半导体ISE Labs宣布于加州圣荷西开设第二个美国厂区。据悉,日月光半导体ISE Labs美国圣荷西新厂区主要负责可靠性和验证程序,服务客户包括人工智能(AI)/机器学习(ML)、先进驾驶辅助系统(ADAS)和高性能计算(HPC)等新兴半导体应用领域的解决方案开发厂商。而弗里蒙特厂则是专注于测试功能,两个厂区的运营总面积超过15万平方英尺(约1.39万平方米)。

图片来源:日月光半导体
迈过去年的行业低谷,今年日月光早早宣布了新一轮资本支出,其增幅达40%至50%,其中65%将用于先进封装和测试。而从实际投资来看,日月光今年资本支出约780亿元新台币,其中超过5成比重用于先进封装测试,测试资本支出将较原先再增加10%。
其全球化布局动作近两年格外活跃。2023年12月下旬,日月光半导体公告,承租中国台湾福雷电子位于高雄楠梓厂房,分别为K21的7楼与K22的7楼,扩充封装产能。产业人士分析,日月光半导体将扩充AI芯片先进封装产能。此前消息显示,日月光高雄厂为应对运营规划,针对先进封装制程的终端测试需求、AI芯片高性能计算及散热需求,购买了大社土地分二期开发。其中,第一期K27厂房已于2023年完工进驻,主要设置Flip Chip及IC测试生产线。
今年1月19日,日月光发布公告,马来西亚子公司投资马币6969.6万令吉取得马来西亚槟城州桂花城科技园土地使用权,应对运营需求。产业人士分析,日月光投控此次在马来西亚槟城的投资,主要是为了布局先进封装产能;今年2月,英飞凌和日月光投控近日同步公告,日月光投控将投资约21亿元新台币(约合4.79亿元人民币)收购英飞凌位于菲律宾和韩国的两座后段封测厂,扩大在车用和工业自动化应用的电源芯片模块封测与导线架封装,最快今年第2季底完成交易;6月21日,日月光半导体再宣布,与日月光旗下宏璟建设在高雄兴建K28厂,预计2026年第四季度完工,重点布局先进封装终端测试以及人工智能(AI)芯片高性能计算。
扩产动作还将持续,日月光半导体执行长吴田玉近日表示,未来在美国、墨西哥、日本及马来西亚都不排除再建置先进封装产能。
2、持续并购,技术和产能扩大都在手中
而在并购上,日月光集团丝毫不手软。据官方消息披露,自1984年成立日月光集团,1990年开启第一步并购芯片测试商福雷电子至今,日月光集团已先后收购了摩托罗拉在中国台湾中坜及韩国坡州的两座封装测试厂、美国硅谷ISE Labs的70%股权、环隆电气20.67%股份、NEC位于日本山形县的封装测试厂、上海张江的威宇科技、恩智浦(NXP)在苏州工厂的60%股权、山东威海爱一和一电子公司、环电98.9%股权、欧洲新义半导体(EEMS)旗下的新加坡工厂、中国台湾洋鼎科技、中国大陆无锡东芝封测厂、中国台湾第二大封测公司矽品精密、英飞凌旗下位于菲律宾和韩国的两座后段封测厂...

如上图所示,日月光集团在不断地兼并收购中拥有了多样化的封装技术,并不断扩充产能,其自身也在丰富独家技术。官方最新消息显示,在新技术方面,日月光投控2023年一共开发了七大技术,包括以覆晶封装进行高频宽记忆体第三代堆迭技术、智慧打线瑕疵检测技术、扇出型封装内埋桥接晶片与被动元件、3D电压调节模组先进封装技术、以内埋式深铜堆声产品开发面板级封装,高整合度SiP封装通讯模组方案以及光学模组封装技术开发等。
而其视为技术招牌的VIPack先进封装平台也在今年3月有了最新进展,2022年,日月光宣布推出VIPack先进封装平台。据悉,VIPack由六大核心封装技术支柱组成,透过全面性整合的生态系统协同合作,包括基于高密度RDL的Fanout Package-on-Package(FOPoP),Fanout Chip-on-Substrate(FOCoS),Fanout Chip-on-Substrate-Bridge(FOCoS-Bridge)和Fanout System-in-Package(FOSiP),以及基于硅穿孔(TSV)的2.5D/3D IC和Co-Packaged Optics。除了提供开拓性高度整合硅封装解决方案(优化时脉速度、频宽和电力传输)的制程能力,VIPack平台更可缩短共同设计时间、产品开发和上市时程。
今年3月22日,日月光半导体发布其VIPack先进封装平台的最新进展——微间距芯粒互连技术。据悉,日月光微间距互连技术在微凸块上采用了新型金属叠层,可实现20 μ m的芯片与晶圆间互联间距,相较以往方案减半,可进一步扩展硅 - 硅互连能力,有助于其他开发过程。日月光微间距互连技术可实现 3D 整合和更高 I / O 密度的内存连接。芯片级互联技术的扩展为 Chiplet 开辟了更多应用,从 AI、移动处理器一直延伸到 MCU 等关键产品。此外,日月光还在加紧布局扇出型晶圆级封装(FOWLP)技术、硅光技术等新一代先进封装。
台积电后起之秀
在高端先进封装上杠到底
台积电在先进封装上的成功,离不开台积电之前的COO蒋尚义和现任台积电系统整合前瞻研发副总经理余振华的放手一搏,更离不开台积电深厚的技术底蕴以及长期运营下来积攒的超级甲方。
1、15年前的CoWoS,差点夭折
2009年张忠谋重新出山,二度掌舵台积电,并请回了已经退休的蒋尚义,希望他带领台积电领先于业内实现28nm制程量产。但是,蒋尚义带来的惊喜不止于此。在他的带领下,2011年台积电超越三星率先量产28nm,同年台积电并宣布,进军封装领域,并直接推出了首个先进封装技术——CoWoS。没错,就是在这两年与HBM高度绑定火爆半导体行业的先进封装技术,只不过在当代,CoWoS又进行了数次升级。
不过15年前这门技术刚问世时,可谓门庭冷落。2011年,仅有FPGA大厂赛灵思一家为其掏了腰包,每个月50片晶圆的订单量让蒋尚义一度苦恼。但值得注意的是,其性能在当时依旧非常出色,凭借CoWoS以及共同开发的硅通孔(TSV)等技术,台积电成功将4个28nm FPGA芯片拼接在一起,推出了史上最大的FPGA芯片。
既然技术没有问题,那问题出在哪里呢?“我只愿意为这个技术花费1美分/平方毫米。”蒋尚义在其后与一位大客户的硏发副总共进晚餐时,对方揭晓了谜底。随后,蒋尚义找到现任台积研发副总的余振华确认,当时CoWoS的价格约为7美分/平方毫米,与客户的需求差了近6倍。
对于晶圆代工出生的台积电入市封装行业,业界并不看好。因为往上到高端先进封装领域,英特尔、三星等已研究先进封装良久,在当时十分火爆的“扇出型晶圆级封装”积攒深厚,台积电在此的技术积累不深。而传统封装领域的竞争则十分的卷,毛利并不吃香。
为了推动其更好的入世,台积电决定给CoWoS做“减法”,开发出廉价版的CoWoS技术,这便是后面火爆的InFO。据悉,CoWoS技术之所以费钱,主要是由于硅中介层,其本质就是一片硅晶圆,还要在中间布线做连接,自然成本高昂。而InFO把硅中介层换成了其他材料,牺牲了连接密度,却换来了成本的大幅下降。
台积电这番灵活做法在随后的无论是制程优化还是技术入市都十分常见,他并不追求技术的一蹴而就,而更追求此时此刻技术与客户的适配。因为有时候太精进的技术在不合适的时代只能束之高楼,但如果放下姿态将会有更多的企业面可以触及并超越。
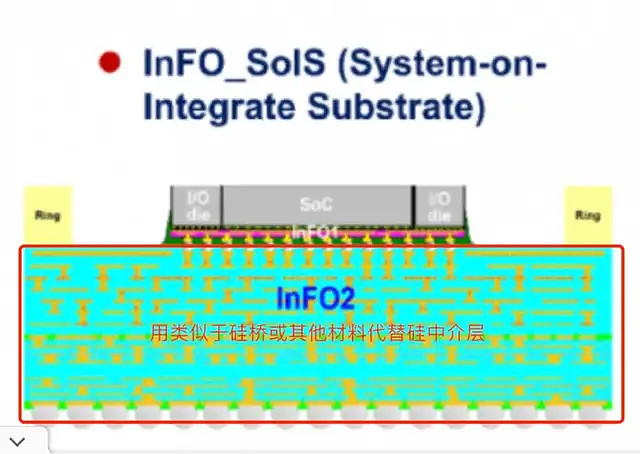
图片来源:经济时报
台积电将CoWoS的成本打下来了以后,紧接着,台积电遇到了它的贵人——苹果。在台积电没有拿出InFO之前,苹果一直使用的是三星的PoP封装方案。但是在当时,三星手机和苹果手机在市场上却打的火热,在此机遇下,台积电缩小芯片效果和性价比都超越PoP封装的InFO成为了苹果的最优解。
2016年,搭载苹果最新A10移动SoC的iPhone 7上市,全部由台积电代工。在CPU速度较前代iPhone 6提高两倍多,内存容量提高一倍的情况下,机身厚度控制在了7.1毫米,是历代iPhone中第二薄的。
自苹果开始,CoWoS封装的客户群便不断扩大,英伟达、AMD、谷歌、英特尔纷纷用上了CoWoS封装。2023年,AI浪潮席卷全球,各类厂商对CoWoS的需求愈演愈烈,台积电多番扩产依旧不足以供应。
台积电在先进封装领域的成功与日月光这类传统封测大厂的发展道路截然不同,他专注于先进制程的发展,通过最大程度发挥先进制程效用适配当下尖端产品的发展,因此其当下更为专注于高性能计算(HPC)、高端智能手机等领域。我们也可以看到,台积电近两年HPC一路高涨,2023年高计算业务与智能手机业务则成为了台积电业绩增长的主要动力。

而在技术上,发展至今,台积电在先进封装上愈发精进,TSMC-SoIC、最新先进封装技术SoW、背部供电等,在未来会给行业带来更大的惊喜。
结 语
日月光和台积电两家的发展历程并不相同,更多的是互相的合作与成就。近期,日月光表示,去年下半年到今年上半年与台积电合作的“oS制程”(CoWoS中的oS),即将在今年看到回报。据悉,日月光投控旗下矽品主要承接台积电CoWoS先进封装的oS段制程。此前台积电和日月光集团均强调,异质整合封装领域很广,比如高速运算(HPC)相关应用。
“日月光有他的角度,台积电有自己的角度”,双方没真正互相竞争,也没干扰,并且各自提供拥有自身长处的异质整合技术,同样创造价值,并让产业更完整。先进封装的道路十分宽阔,技术良多,为了让行业生态更加完善,各家均在竞争中合力共进,正如日月光和台积电一般,向上发展,各有各的精彩。