
过去十多年来,手机通信功能发生了翻天覆地的变化。一方面通信制式从针对地区和运营商的特定设计向“全球通”设计转变,另一方面通信技术从2G向5G演进,得以实现这一巨大变革的原因正是功率放大器(PA)、滤波器、天线、开关和低噪声放大器(LNA)等支撑通信功能的射频器件的不断升级换代。随着手机智能化提升,需要支持的通信频段、交互通道增多、带宽变大,对射频前端器件的数量和功能要求大幅提升,手机中的射频前端方案日益集成化、小型化、模组化,高集成度射频前端模组已是大势所趋。
受5G渗透率提升的驱动,Yole数据显示射频前端市场规模在2021年达到了190亿美元,预计到2028年将增长至269亿美元;进入2022年后,全球消费电子市场持续低迷,射频前端市场基本与2021年持平,但中长期来看,这一市场仍然充满前景。
近几年在国内庞大的终端市场需求、国产替代浪潮及资本加持下,中国射频前端产业发展步入快轨,一批具有代表性的射频前端企业不断涌现。不过,虽然5G技术的应用进一步拉升了射频前端器件市场空间,但国内厂商一时间难攻破由Skyworks、高通、Qorvo、博通与村田等国际射频巨头建立的市场壁垒,在行业进入下一个高速增长周期前,本土射频前端产业链从设计、制造到封测,向模组化、高端化市场进阶的需求日益迫切。
国产射频前端产业迈向高端的壁垒——模组化
根据集成方式的不同,射频前端模组主集天线射频链路包括FEMiD(集成射频开关、滤波器和双工器)、PAMiD(集成多模式多频带PA和FEMiD)、L-PAMiD(LNA、集成多模式多频带PA和FEMiD)等;分集天线射频链路可分为DiFEM(集成射频开关和滤波器)、LFEM(集成射频开关、低噪声放大器和滤波器)等。
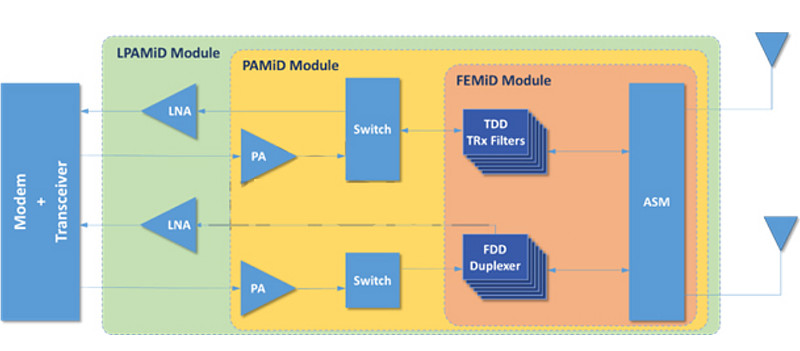
主集天线射频链路
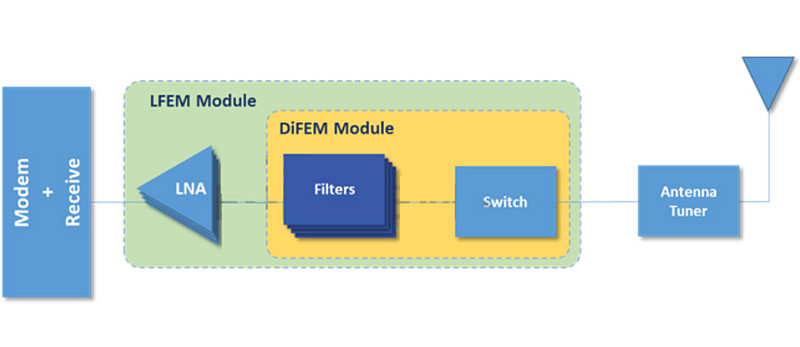
分集天线射频链路
由上图射频前端模组的组成结构不难看出,L-PAMiD模组是集成了目前常见的分立多模多频PA、LNA、射频开关、滤波器以及双工器等独立射频器件的射频前端模组,也是目前集成度最高、设计难度最大、封装工艺最复杂的射频前端模组。这类高端射频模组的市场,目前主要由美商博通、Qorvo、Skyworks、高通(RF360)等厂商占据。
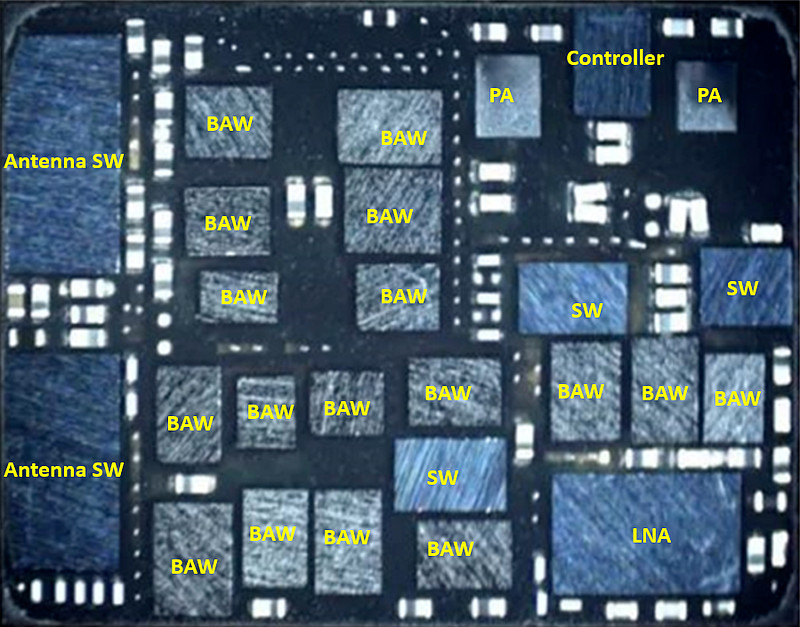
M/H LPAMiD开盖图 来源:Qorvo
从Qorvo公司M/H L-PAMiD模组可见,该类产品集成了17颗BAW,2颗GaAs HBT,以及6颗SoI和1颗CMOS控制器,设计以及封装技术难度堪称射频前端领域最高。相比于单颗分立PA芯片的价格已经降到几十美分,这类复杂模组的售价可以达到3~4美元甚至更高。因此射频模组是未来射频前端器件的必然之路,有望成为竞争的主战场。
Yole预测,到2026年,射频前端模组市场规模将达到155.38亿美元,约占射频芯片市场的71.70%。其中接收模组市场规模将达到33.39亿美元,发射端PA模组市场规模可达到94.82亿美元。目前智能手机中高端机型多使用集成度高的PAMiD/L-PAMiD方案,但中低端机型也开始配置L-PAMiD,方案呈现下沉趋势。
观察国内射频前端产业,当前已经在PA、开关、天线等领域取得了令人欣喜的成绩,例如在2G至4G的单颗分立PA上国产厂商占据了全球市场的主导地位,5G PA市占率也在稳步提升,射频开关/LNA领域更是诞生了全球龙头企业。
但模组方面,即使是简单的5G PAMiF和LFEM模组领域,国内也才起步量产2年左右,由于设计集成难度大且受制于没有自己的SAW 和BAW技术,大部分企业只能从国外大厂采购滤波器,这又面临供应受限的可能,因此国内几家领先的射频公司也才刚起步研发和小量试产L-PAMiD SiP模组,相比于上文提及的4家美国射频巨头公司落后了5年以上的时间。
可喜的是,国内众多射频前端企业早已聚焦于研发生产SAW和BAW滤波器,在研发和工艺提升方面都取得了重大的进步,开始有能力为国内射频前端模组的设计、研发和生产提供保障。虽然在性能指标和工艺制程方面与国际巨头仍有不小的差距,但是已经可以满足基本要求,模组设计公司也要在实际使用过程中不断和国内滤波器厂家进行合作试用、找差、改进、再试用的循环推进,共同保障国内高端射频PAMiD SiP模组的设计研发和生产供应,在努力追赶国外巨头技术的同时,做到关键器件的国产替代和自主可控。
射频前端模组设计和封测挑战与日俱增
射频前端模组作为高度集成的器件,核心在于需要极强的系统整合能力,对整个模组架构、设计、封测都提出了更高的要求,包括简化设计、小型化、降低能耗、降低解决方案成本、提高系统性能等诸多方面。除了设计,射频前端模组对封测能力也提出了更高的要求。
例如2022年华天科技率先与国内2家射频设计公司合作研发的L-PAMiD模组,产品设计要求在更小的尺寸上实现产品功能的高度集成带来了产品内部的高密度贴装,其中被动元器件间距、WLP与die间距、die to die间距等都在突破现有封装设计规则,这给SMT贴装、清洗、塑封等制程带来了巨大的挑战,GaAs芯片容易发生crack、SAW(WLCSP封装)滤波器的bump void 和虚焊问题,以及挑战目前SMT贴装极限能力的008004(公制0201)MLCC器件的贴装和塑封完全填充,都是L-PAMiD模组封装过程中要解决的工艺难点。
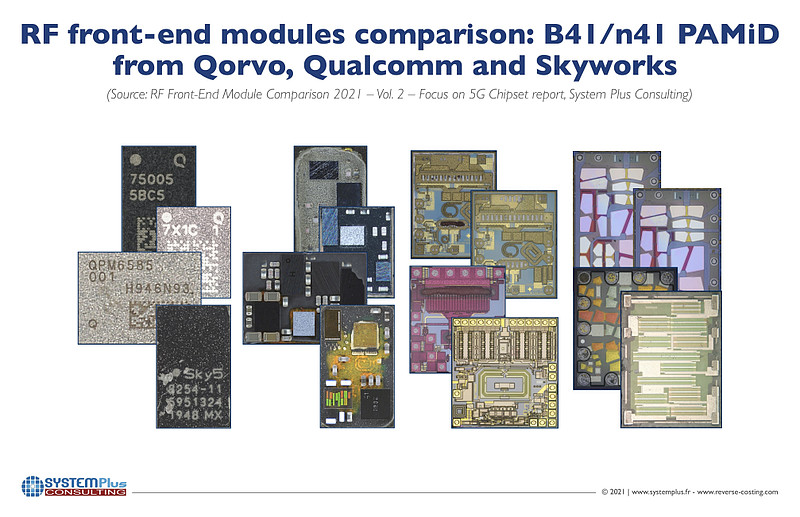
来源:Yole
此外,对于SiP而言,由于系统级封装内部走线的密度非常高,普通的PCB难以承载;而IC载板的多层数+低线宽线距则更加契合SiP要求,更适合作为SiP的封装载体。为了追求产品极致性能和高可靠性,华天科技协同客户开发的L-PAMiD模组采用了coreless工艺的8层基板,要求基板侧面有多层漏铜来增强EMI Shielding电磁屏蔽性能,且模组背面四角焊盘使用绿油开窗增大焊盘面积提升产品板级可靠性;这些特殊设计在封装过程中产生诸工艺难题,如成品切割时的基板绿油分层、侧面铜层氧化/变形、Sputter溢镀和镀层分层等,给产品封装带来了很大的工艺难度。
华天科技指出,从最简单的分集模组DiFEM、LiFEM到集成度最高的L-PAMiD等主集模组,实现的功能越来越多,也要求越来越多的分立器件集成在一个模组中,而且手机要求模组的尺寸越小越好,这对产品设计带来了极大地挑战,需要不断突破现有的设计规则上限。此外,模组中集成的不同滤波器采用了不同的材料和制造工艺,包含了LTCC、WLP和CSP三种主要的封装形式,在模组封装中都面临不同的挑战。比如LTCC主要需解决焊接后倾斜和塑封完全填充的封装难题;WLP主要需要解决bump虚焊和bump void的封装难题;CSP则最主要是解决背面焊盘焊接后的锡膏空洞过大和塑封完全填充的难题。
因此随着模组中器件的密集度更高,如何保证封装中的贴装精度、焊接后彻底清洗干净、塑封完全填充严实、EMI shiedling的全覆盖和结合性、产品可以经受严格可靠性考核等都是模组封装面临的重要考验。
华天科技DSMBGA封装量产在即,助力国产射频前端更进一步
5G到来之后,手机终端需要支持更多的频段。并且5G定义了3GHz以上、6GHz以下的超高频(UHB)频段,对射频前端性能提出了更高要求,单部手机中的射频前端模块数量不断增加,以往射频前端模组所采用的单面SiP逐渐无法满足有限空间的小型化要求,DSMBGA(Double Side Molding BGA)双面塑封BGA SiP工艺走上舞台,并逐渐成为行业技术的未来发展方向。
DSMBGA主要用于射频前端模组领域,将原先的单面SiP模组做成双面后,模组的外形尺寸减少20%以上,产品厚度只增加不到0.2mm,而且将多个频段集成在一个模组实现,可以更好地满足手机对模组更小尺寸、更全性能的要求。
伴随着国产射频前端模组向最高集成度稳步迈进,国内可与之匹配的先进封装技术的同步发展也迫在眉睫。
华天科技自2015年开始射频PA产品的封装技术研发和生产工作,客户覆盖国内主要PA设计公司。从早期的2G/3G/4G PA,到近两年的5G PA模组封装都保持着国内封装厂商的领先地位和主要市场份额。
在射频前端模组领域,华天科技早在2019年协同客户一起进行5G L-PAMiF和L-FEM模组套片的封装工艺研发和工程样品试制。针对GaAs FC die的特殊材质和bump结构易发生UBM crack、bump crack的高风险点,华天科技基于内部仿真数据指导,和多年单颗分立射频器件封装经验积累,从基板设计、塑封料选择、超薄钢网小颗粒锡膏的连续稳定印刷、化学水洗工艺匹配、塑封工艺优化等多个技术难题进行了攻关突破,成功保证了5G L-PAMiF和L-FEM模组在国内率先量产,目前已经累计出货过亿颗,未发生产品质量异常客诉。客户产品性能优异,比肩国际竞商产品,也率先进入三星、vivo等手机品牌供应链。
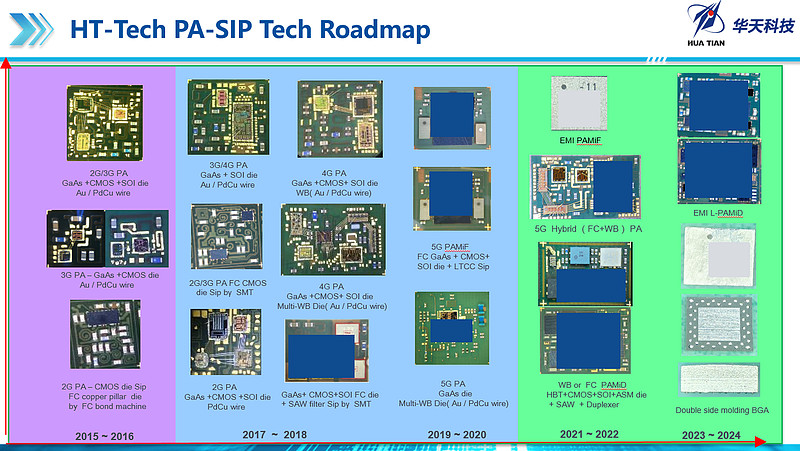
华天科技射频前端模组产品技术路线图
继5G L-PAMiF模组的研发生产保持国内封装厂商领先地位的基础上,基于过去3年积累的量产经验,华天科技于2022开始在L-PAMiD模组上集中工程力量进行技术攻关,通过大量的工程DOE实验,成功解决了前文列举的各项封装工艺难题,封装产品通过了客户的性能测试和多次可靠性考核,仅用时5个月就实现了产品从NPI build到100K再到KK级的量产规模,产品封装测试良率、可靠性均满足客户要求,再次取得了射频模组封装工艺研发和规模量产在国内封装厂商的领先地位。
2023年以来,华天科技与多家射频设计公司联合进行DSMBGA产品的封装工艺研发,封装技术的主要挑战在于如何保证塑封后的基板翘曲平整度、密集器件和滤波器、die的塑封完全填充、strip grinding精度控制和防止die crack、激光烧球准确度控制、EMI共形屏蔽和分腔屏蔽实现等等。目前,华天科技已基本解决以上封装工艺难题,双面塑封产品线已经建立,6月底已经完成国内某客户首个产品工程样品的客户送样,年内有望实现量产。
据悉,华天科技目前正和客户合作研发迄今为止国内封装厂最复杂的DSMBGA产品,在技术攻关和量产实现后,华天科技不仅将持续保持国内射频模组SiP封装的领头羊地位,还将极大地刺激和鼓励国内射频前端设计公司向双面塑封方向投入研发,助力客户追赶国外射频巨头如Skyworks、Qrovo、博通等企业,为国产射频前端产业添砖加瓦!