前言:英特尔发布玻璃基板实现更强大算力,TGV玻璃基巨量互通技术成关键,有乡亲希望我能聊聊TGV技术,安排!
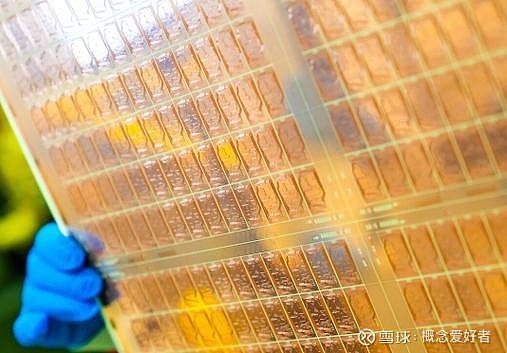
特别说明:
有看官对我各种系列觉得好奇,想问问我是如何分类的。这里统一回复下:
对于任何的题材实际都要经历四个阶段,分别是:萌芽、成长、爆发和衰退。我不同的系列实际对应的就是不同的阶段。
萌芽阶段:依赖于专业深度和人脉广度,可以通过我的置顶文章找到路径。
成长阶段:依赖于资金厚度和政策力度,也就是「前瞻系列」的由来。
爆发阶段:依赖于市场氛围和专业深度,这就是「风口系列」的由来。
衰退阶段:潮起就有潮落,这阶段或许还比较火,我会尽我所能给大家做「吹哨人」。
同时,为了方便诸位对于热门题材的评估跟踪,我这里借鉴这几年私募界比较流行的题材活跃度指数进行了综合评级,具体见文末相关个股部分的介绍。
本篇目录
1.来龙去脉
2.产业背景
3.认识TGV技术
4.细分赛道
5.市场空间
6.相关上市公司
7.独家核心提示
一,来龙去脉
据业内消息人士透露,英特尔已加大了与多家设备和材料供应商的订单,以生产基于玻璃基板技术的下一代先进封装,预计将于2030年投入量产。
东方财富证券研报指出,高算力需求驱动封装方式的演进,2.5D/3D、Chiplet等先进封装技术市场规模逐渐扩大。由于结构堆叠、芯片算力提升等因素影响,先进封装技术目前还面临一些问题,例如晶圆翘曲、焊点可靠性问题、TSV可靠性问题、RDL可靠性问题以及封装散热问题,寻找更合适的材料、采用新的工艺以及更精确先进的设备成为破局重点。其中,封装基板是先进封装中的重要材料。相比于有机基板,玻璃基板可显著改善电气和机械性能,能满足更大尺寸的封装需求,是未来先进封装发展的重要方向。长城证券邹兰兰表示,玻璃基板在先进封装领域的应用前景得到行验证,国内玻璃基板精加工企业有望获得切入半导体领域的机会。
二,产业背景
技术及成本因素推动芯片产业迈入后摩尔时代。2015 年后,芯片制程发展进入瓶颈期,7nm、 5nm 制程的芯片量产进度均落后于预期。一方面,芯片制程工艺已接近物理尺寸的极限 1nm,量子隧穿效应对晶体管功能造成很大削弱,另一方面,建设新一代制程晶圆厂的成本水涨船高。所以,芯片产业迈入了后摩尔时代。

先进封装已经成为后摩尔时代集成电路技术发展的一条重要路径。后摩尔时代,芯片的发展逐渐演化出了不同的技术方向。发展摩尔定律演进过程中未开拓的技术方向,先进封装便是其中之一,其可以实现更高的 I/O 密度、更快的信号传输速度和更好的电热性能,从而提高芯片的性能和功能。并且,先进封装技术还可以降低芯片的功耗和体积,提升芯片的可靠性和生产效率。
TSV 技术实现 Z 轴电气延伸和互连。通过 TSV 技术,可以将多个芯片进行垂直堆叠并互连。按照集成类型的不同分为 2.5D TSV 和 3D TSV,在 3D TSV 中,芯片相互靠近,所以延迟会更少,且互连长度缩短,能减少相关寄生效应,使器件以更高的频率运行,从而转化为性能改进,并更大程度的降低成本。
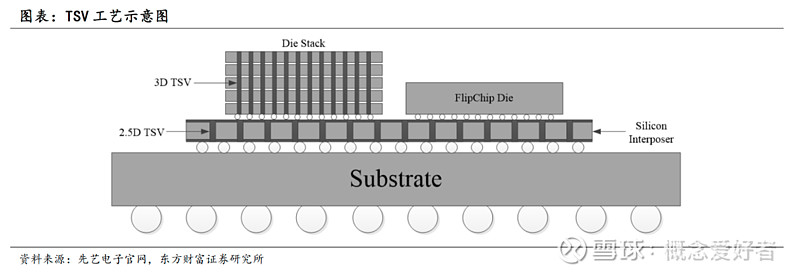
三,认识TGV技术
作为一种可能替代硅基转接板的材料,TGV (Through Glass Via,玻璃通孔)转接板成为半导体企业和科研院所的研究热点。相较硅基转接板,玻璃转接板优势显著。
1. TGV 成孔技术:方法众多,各有优劣
TGV 成孔技术需兼顾成本、速度及质量要求。制约玻璃通孔技术发展的主要困难之一是 TGV 成孔技术,其需要满足高速、高精度、窄节距、侧壁光滑、垂直度好以及低成本等一系列要求。

激光诱导刻蚀优势明显且已获应用,有望在成孔技术中脱颖而出。该技术的优点如下:①成孔质量均匀,一致性好,无裂纹;②成孔速率快,可达到 290 TGV/s;③TGV 形貌可调,由于刻蚀的各向异性,可以通过调节激光参数来控制 TGV 的垂直度和形貌。德国乐普科(LPKF)公司率先用该技术实现了玻璃通孔制备。
2.TGV 填孔技术:金属填充或电镀薄层
类似 TSV 的金属填充方案可应用在 TGV 金属填充中。国内厦门云天半导体通过试验研究,开发了完整无缺陷填充的 TGV 通孔技术。除电镀填实外,TGV 也可采用孔内电镀薄层实现电学连接。
四,细分赛道
1.激光诱导刻蚀设备
激光刻蚀设备为成孔工艺核心设备,国内厂商已有覆盖。德国 LPKF 是全球领先的激光加工解决方案供应商,国内方面大族激光及帝尔激光已有相关产品覆盖,在 TGV 孔径及精度方面不落下风,其中帝尔激光已于 2022 年 3 月实现首台 TGV 激光微孔设备出货。
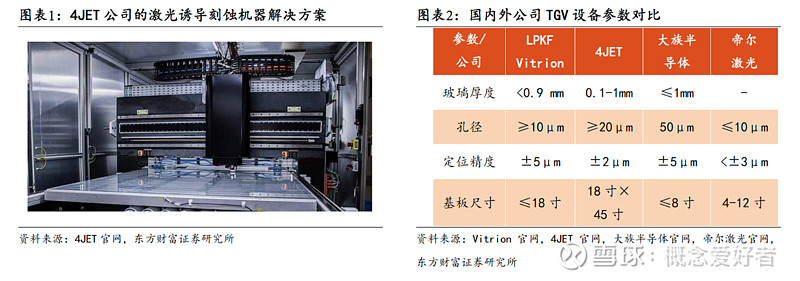
2.电镀设备及电镀液
电镀为填孔工艺核心,电镀液体系与TSV相似,由基础镀液及添加剂构成。高质量镀液为美日德垄断,国产替代道阻且长。近年来国内的上海新阳、飞凯材料、深圳创智芯联公司等也开发了用于先进封装的互连电镀液,但还是和国外存在非常大的差距,大多数仍旧采用国外的电镀液,未来需继续加大对电镀液的研究,以期追赶上国外的水平。
电镀设备同为国外龙头垄断,国内盛美上海初具匹敌实力。盛美上海自成立之初就聚焦铜互连技术,是世界上较早进入水平电镀领域并自主掌握电镀核心技术的企业之一,目前盛美上海自创的电镀技术已在前道双大马士革和先进封装、3D TSV 以及第三代半导体应用领域均实现了质的飞跃。此外,上海新阳、深圳创智芯联也进行了相关电镀设备的生产。
五,市场需求
1.新一代 AI 芯片仍采取 CoWoS 封装,转接板替代或为 TGV 打开成长空间。
CoWoS(Chip on Wafer on Substrate)是台积电推出的 2.5D 封装技术,目前,CoWoS 已经获得 NVIDIA、AMD、Google、XilinX、华为海思等高端芯片厂商的支持。新一代 AI 芯片仍采取 CoWoS 封装,英伟达最新的 H100 加速计算卡仍采用 CoWoS-S 封装。
CoWoS 封装的核心之一为硅转接板及 TSV 工艺,但其存在成本高和电学性能差等不足,而玻璃转接板及 TGV 工艺具有低成本、易获取、高频电学特性优良等特性,有望作为前者替代品。因此,我们认为 TGV 替代 TSV 将成为先进封装核心演进方向之一,叠加AI 浪潮之下加速计算芯片需求高增,TGV 远期成长空间广阔。
2.TSV 实现电气连接及热传导,玻璃载板为 MIP 更优之选。
Micro LED 趋势明朗,MIP 封装优势明显。以玻璃材料为 LED 芯片载板,可提升 MIP 封装可靠性,国内沃格光电率先发力,Micro LED 载板产品均有序推进。据 DSCC(Display Supply Chain Consultants)咨询公司,Micro LED 屏幕出货量未来将成倍增长,由 2023 的45 万片/年增长至 2027 年的 1747 万片,复合增长率近 150%;市场规模则由 0.44亿美元增至约 14 亿美元,复合增长率近 140%。
3.MEMS:TGV 及玻璃基应用日趋成熟,需求扩张更添成长动力
MEMS(Micro Electromechanical System),即微机电系统,是微型机械加工工艺和半导体工艺相结合的产品。于玻璃转接板相比于硅转接板的明显优势,也被广泛应用于 MEMS 封装中。MEMS 设计制造已有玻璃基材及 TGV 技术导入。国内赛微电子子公司 silex microsystems 将 TGV 工艺导入 MEMS 代工,实现适用于射频和其他低电容应用的玻璃晶圆封装。
4.封装与集成天线:技术路径日趋完备,实际应用有望提速
1)封装天线
封装天线(AiP,Antenna in package)是通过封装技术将天线与电路集成在一起,实现天线和射频元件的整合单一封装。玻璃通孔+扇出晶圆级封装(FOWLP)为天线封装开辟新路径。玻璃通孔技术不仅可以用于制作 TGV,还可以在玻璃上制作空腔,进而为芯片的封装提供一种名为嵌入式玻璃扇出(eGFO)的新方案。该方案是将 FOWLP 工艺与封装天线技术进行结合,采用三维堆叠方式实现封装天线的基础模块,从而满足天线单元的轻薄化,很好地兼顾天线的性能、成本以及体积,最终促成采用 FOWLP 工艺制备的封装天线的低成本广泛应用。
2)太赫兹天线
太赫兹(THz)波是指频率在 0.1-10THz(波长为 3000-30m)范围内的电磁波。TGV 技术助力太赫兹天线制备。国内厦门大学基于先进封装及微纳制造技术制备了高频波导缝隙天线,创新性地引入 TGV 加工波导缝隙天线,得到高能太赫兹天线。太赫兹频段具有更高的绝对带宽,可以满足不断增长的高数据传输率的无线通信需求,有望支持更高的用户密度、更少的延迟、更好的频谱利用率,是未来 6G 通信的主要手段。
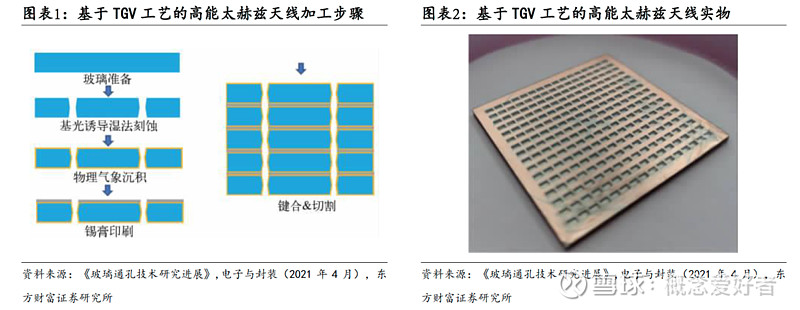
5.集成无源器件:玻璃材质性能优势突出
集成无源器件(IPD,Integrated Passive Component)由电阻器、电感器和电容器等无源元件组成,通常使用标准制造技术,凭借优异的高频电学性能,玻璃基板被广泛用于集成无源元件。国内方面,云天半导体率先开发了基于玻璃基板 IPD 集成技术(WL-IPD),开展了高 Q 值电感、微带滤波器、天线、变压器等一系列射频器件研发,具有低成本,高性能,易于三维集成等突出优点。
6.玻璃载板:载板材质升级新方向,未来或与 ABF 并驾齐驱
Chiplet 技术风潮之下产业转向大尺寸封装及小芯片设计,大型数据中心 GPU 均使用小芯片封装,封装重要程度日渐提升,进而给封装材料提出新需求。作为替代方案的玻璃载板进入视线,玻璃载板具有比 ABF 载板更光滑的表面,厚度降低四分之一以上,且使芯片的性能提高、功耗下降。尽管玻璃载板商业化尚需时日,但其有望成为载板行业的规则改变者。玻璃芯载板+TGV 技术已有产品问世,导入先进封装指日可待。
五,市场空间
先进封装方兴未艾,规模+份额持续提升。在电子装置小型化,以及 5G、 AI 等对高速与高效运算、高带宽、低延迟、低功耗等的需求推动下,先进封装已成为半导体创新、增强功效和提升成本效益的关键。据 Yole 咨询公司,全球先进封装市场规模持续增长,预计 2027 年将达到 652 亿美元,6 年复合增长率9.73%,其中 TGV/TSV 所属的 2.5D/3D 工艺市场规模也将增至约 150 亿美元,复合增长率超 14%。此外,先进封装市场占比稳步提升,2022 年约为 42%,预计2027 年将达到 52%,首次超过主流封装。

TGV 衬底格局集中,国外厂商份额领先。国内方面,目前有厦门云天半导体实现批量供货,其二期工厂(建筑面积约 24000 平方米,引入 8 寸、12 寸晶圆级封装工艺设备)于 2021 年投产使用,提供 WLP/3DWLCSP/Fan-out 等封装技术以及玻璃通孔工艺和集成无源器件(IPD)制造能力。此外,国内沃格光电等企业也取得不同程度进展。
六,相关上市公司
为方便大家对我每天整理的题材、概念涉及的个股进行收集、归纳、整理,即日起,我按照发布时间将每天涉及的板块个股做合集清单,方便大家翻阅,见下图
特别说明:以下仅为部分个股,个股业务匹配度有差异,故表现有强弱、先后区分,故需进一步阅读对应的第三方独立「个股报告」进行筛选,但因版权方要求,「个股报告」仅在「内部报告」栏目提供。

PS:关于图片显示不完整
1)个股大家可以自己收集,关键还是看逻辑,我也只是收集整理,并不涉及判断好坏
2)图片较大,全部上传,清晰度不够
3)「高匹配度个股核心内容解读」涉及商业利益,不适合在公众平台发布
七,独家核心提示
「前瞻系列」,自然是有些超前的,超前并不等于没有表现,但至少说明目前还没有被市场充分挖掘,而其中最容易出现的就是个股行情带动板块行情,所以在个股的把握上更为重要,这时候特别要关注「公司业务匹配度」的情况,也就是「高匹配度个股核心内容解读」中的内容,只有关联度高才能有持续表现。
以上是我自己研究的方向和思路,也就是和大家一起分享下。
本人不推荐任何个股,不收会员,没有QQ群,也没有微信群,也从不与任何人发生利益关系,所有信息只为自己学习使用,不作为买卖依据,买者自负,卖者也自负。
老概不求名不求利,但求各位乡亲看完之后点个赞,关注下,如果能留个言表个态更好,赠人玫瑰,手有余香,如果有说得不理想的地方,还求大家轻拍。
$彩虹股份(SH600707)$ $鸿利智汇(SZ300219)$ $沃格光电(SH603773)$