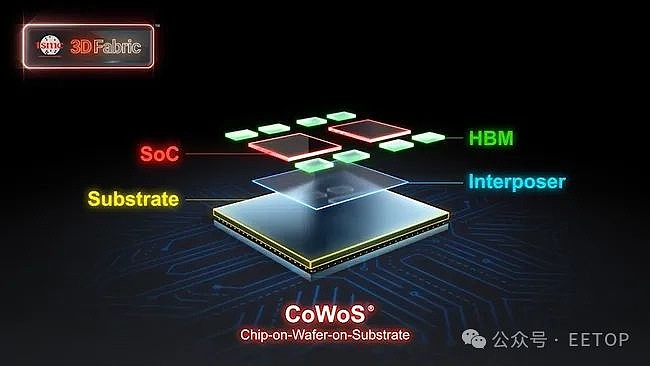
据日经新闻报道,台积电正在开发一种新的先进芯片封装方法,使用矩形面板状基板,以满足对先进多小芯片处理器日益增长的需求。该开发仍处于早期阶段,可能需要数年时间才能商业化,但如果实现,对于全球最大的芯片制造商来说,这将是一个重大的技术变革。
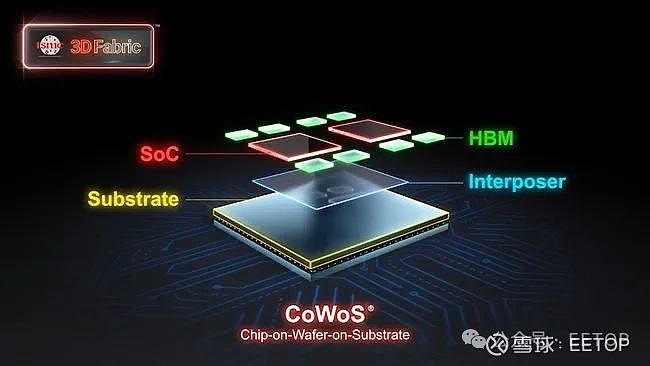
据报道,台积电的新方法使用尺寸为510mm x 515mm的矩形基板,而不是直径为300mm的晶圆。这些面板的可用面积比传统的 300 毫米圆形晶圆大约 3.7 倍,允许每个晶圆生产更多的芯片,并减少边缘的浪费。然而,新方法需要全新的设备,这意味着台积电将无法使用传统的晶圆厂工具。报道称,台积电目前正在与设备和材料供应商合作开发这种新的技术,但没有详细说明。
“台积电密切关注先进封装的进展和发展,包括面板级封装,”台积电在日经新闻发表的一份声明中写道。
该公司目前的先进芯片封装技术,如CoWoS(基板上的芯片),使用300毫米硅晶圆,对于为英伟达、AMD、亚马逊和谷歌等客户生产人工智能处理器至关重要。然而,随着人工智能芯片尺寸和复杂性的增长,这些方法的效率可能会下降,从而促使需要新的矩形基板。
过渡到矩形基板在技术上具有挑战性,需要对生产工具和材料进行重大更改。芯片生产所需的精度高于显示器和PCB制造所需的精度,这使得这种转变变得复杂。
这种向矩形基板的过渡被认为是一项长期计划,可能需要五到十年的时间。有必要对设施进行重大检修,包括升级机械臂和自动物料搬运系统,以适应新的基材形状并确保这种先进封装方法的成功。
台积电雄厚的财力和行业影响力对于推动设备制造商适应变化至关重要,但该计划是否会实现还有待观察。
据《日经新闻》报道,包括英特尔和三星在内的其他行业参与者也在探索面板级封装,据报道,Powertech Technology 等公司以及京东方科技和中国台湾群创光电等显示面板制造商正在投资这项技术,以多元化进入半导体行业。