每天10分钟,全面了解一个行业#封测# $北方华创(SZ002371)$ $中微公司(SH688012)$ $华海清科(SH688120)$
封测设备

公开资料整理自用,完整性和准确性不做保证。
不作为投资建议。
半导体封测流程与所需设备

封装技术升级路线
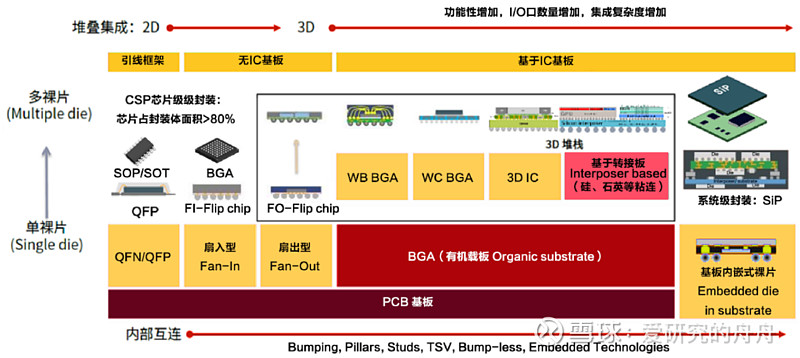
封装行业空间

封装市场格局

封装产业链

封测设备市场规模

封测设备①:固晶机
固晶机简介:固晶机,也称为贴片机,由多个部分组成,包括取料结构、推料结构等。其功能是通过定位和对准等步骤,将芯片通过银胶粘接到基板或封装体上,保证电连接、热传导和机械强度。它服务于LED、逻辑芯片等行业,是先进封装的核心设备,其成本占总体的30%-40%。
2.固晶机市场与行业格局

相关公司

华封科技(未上市)是国内高端贴片机领军企业,产品精度高达3微米,得到了多个头部厂商的大量复购订单。新益昌是国内LED固晶设备龙头厂商,产品在半导体领域有广泛应用。其他固晶机企业包括深科达、凯格精机等。
封测设备②:模塑机
模塑机简介:
半导体封装的塑封工艺是将封装材料在一定条件下导入,包裹并固化集成电路核心。这种工艺可以保护集成电路,便于标准化装配,并改善芯片热性能。全球半导体塑封机市场预计在2030年达到8.77亿美元。塑封设备主要有注塑型和压缩成型两种,广泛应用于引线框架、电源模块等封装,以及3D NAND闪存、处理器等封装过程中。
模塑机行业格局
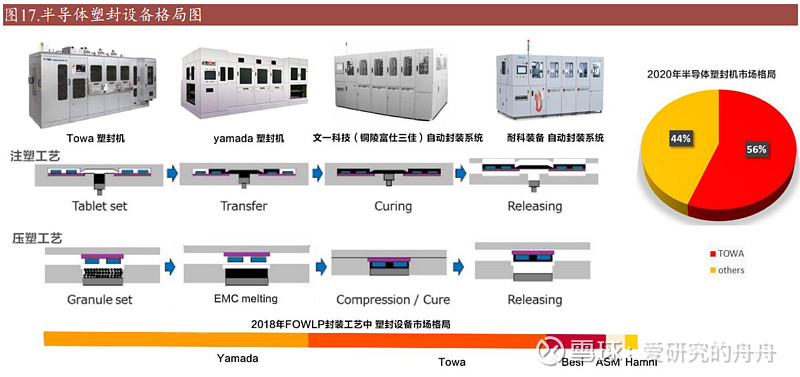
相关公司
耐科装备开发了动态PID压力控制等核心技术,并成功研制出半导体塑封设备和模具,为国内多个半导体封装知名企业供货。
文一科技是老牌半导体封装设备供应商,主要生产半导体集成电路封装模具等,正在研发满足先进封装用模具和设备。
封测设备③:划片机
划片机简介:
划片机在封装和硅片生产中有重要作用,主要包括砂轮划片机和激光划片机。其中,砂轮划片机是综合了多项技术的精密数控设备,而激光划片机则利用高能激光束进行划片。由于热影响区的问题,目前主要使用砂轮划片机。划片机的核心零件包括高精密气浮主轴、刀片等。随着先进封装产业和半导体行业的发展,划片机市场规模正在快速扩张。
2.划片机概览
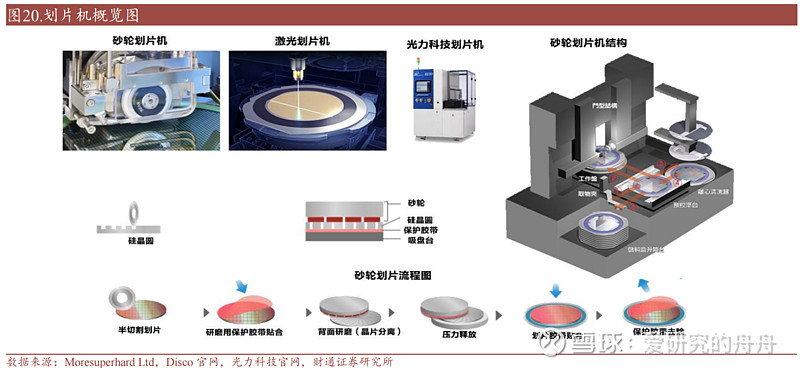
3.相关公司

海外划片机龙头为日本 Disco 和东京精密。光力科技、和研科技、京创先进在光电等泛半导体切割划片领域基本实现了国产替代,正发力集成电路半导体用划片机。国内其他划片机生产商包括艾凯瑞斯、蓝瑟半导体、博捷芯、汉为科技
封测设备④:引线键合机
引线键合机简介:
引线键合是一种使用细金属线实现芯片与基板间电气互连的工艺技术,广泛应用于传统封装中。引线键合机是该环节的核心设备。键合线种类多样,包括金线、铜线、铝线等。引线键合机市场高度集中,主要由库力索法和ASM Pacific两家公司垄断,国产化率仅为3%。
2.引线键合机概览:
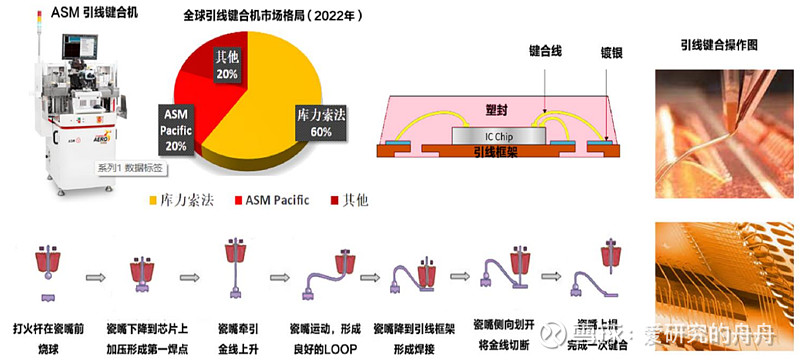
3.相关公司:
奥特维 2018 年立项研发铝线键合机,并于 2021 年初发往客户端测试。
无锡德力芯通过大半年的验证,对奥特维铝线键合机产品性能予以高度肯定,并采购数台设备,半导体业务取得突破性进展。
新益昌的粗铝丝压焊机科用于半导体功率器件的引线键合,全自动多维引线焊线机可用于半导体激光二极管封装。
封测设备⑤:研磨减薄机
研磨减薄机简介:
晶圆减薄是将晶圆磨削至超薄状态,以减小封装后的高度和体积,改善芯片性能,并减少划片的加工量。这是多层堆叠技术和先进封装技术的核心设备。在减薄过程中,晶圆可能会破裂或翘曲,因此需要保护措施。晶圆减薄主要采用机械研磨方法,包括粗磨、精磨和化学机械抛光。
2.晶圆减薄机概览
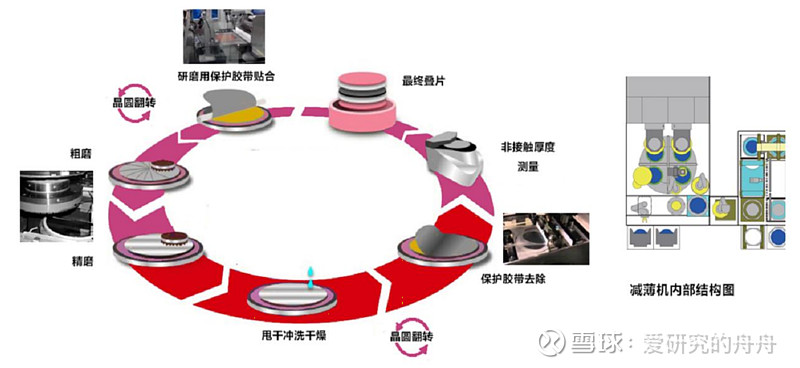
相关公司
全球减薄机市场规模约为9.4亿美元,领先企业包括日本Disco、东京精密等。为满足国内需求,华海清科和电科装备等公司积极布局晶圆减薄设备,并取得了重要突破,实现了量产出货。

封测设备⑥:晶圆键合机
晶圆键合机简介:
键合技术通过堆叠晶圆,实现集成电路的三维短距离互连,提高信息传输速度并缩小器件体积。晶圆键合技术包括临时键合和永久键合两类。临时键合具有更高的灵活性,而永久键合通过化学和物理方法将晶片紧密结合。金属热压键合需要使用高压,而熔融键合/混合键合只需常温键合与低温退火,因此得到广泛使用。
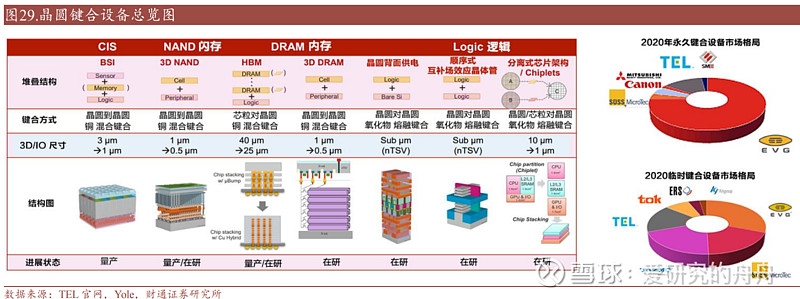
2.晶圆键合机概览
3.相关公司:
全球大多数键合机由德国SUSS和奥地利EVG生产。
拓荆科技已成功研发两种混合键合设备并取得了突破,芯源微成功研发临时键合机、解键合机,
华卓精科的键合机在上海集成、先方半导体等有收入,
苏州芯睿科技也生产晶圆键合机。
封测设备⑦:封装光刻机
封装光刻机简介:
后道光刻机是芯片封装工艺的重要设备,用于制造微凸点、铜柱等结构,对提升芯片性能、缩小尺寸有重要作用。与前道光刻机相比,后道光刻机技术难度较低,但有特殊技术要求。
2.封装光刻机概览:
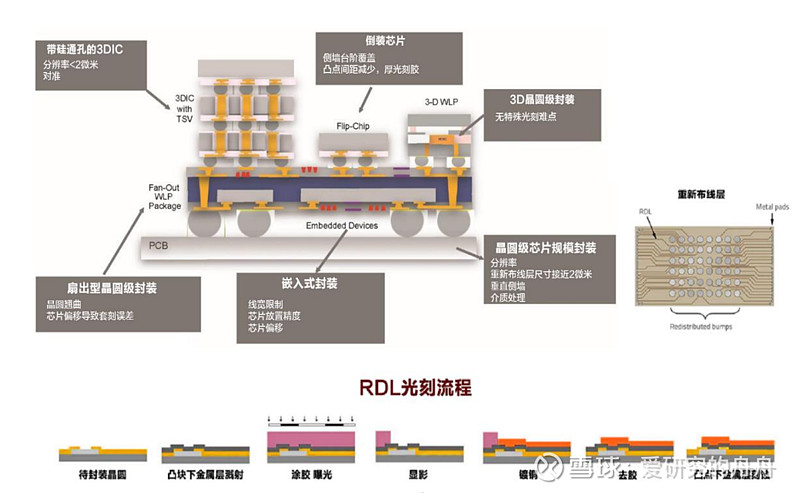
3.相关公司

全球封装用光刻机市场规模约为1.42亿美元,主要生产商有上海微电子、Veeco、佳能等。随着先进封装技术升级,对光刻机精度要求提高。国内主要生产商有上海微电子和芯碁微装。上海微电子已成功推出2.5D/3D先进封装光刻机,填补国内空白。芯碁微装的WLP2000晶圆级封装直写光刻机已发运至客户。
封测设备⑧硅通孔设备
硅通孔设备简介:
硅通孔刻(TSV)是一种先进的封装技术,通过填充导电物质实现硅通孔的垂直电气互联,降低信号延迟。TSV技术在2.5D/3D封装中被广泛应用,提高了互连密度和通讯速度。TSV采用深反应离子刻蚀、绝缘层淀积等技术生成,可以集成到制造工艺的不同阶段。制作硅通孔的刻蚀机精度稍低,但对刻蚀速率、深宽比等有严格要求,国内只有少数企业具备量产能力。
硅通孔设备概览
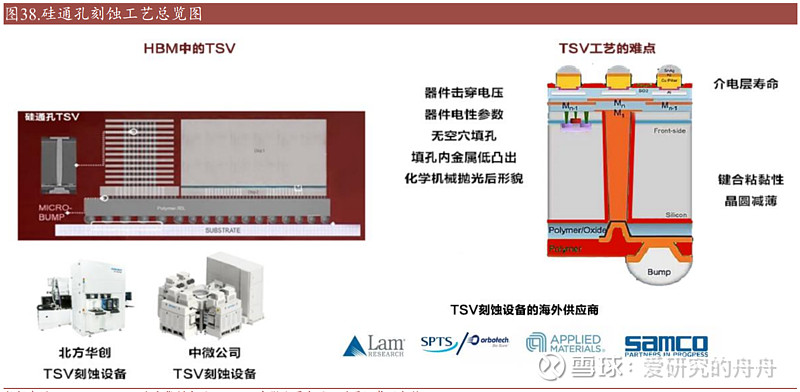
相关公司
中微公司的 Primo TSV 刻蚀机在全球范围内已取得较大市场份额。北方华创于2020 推出 TSV 深硅刻蚀机 PSE V300,其性能达到国际主流水平,2023 年 6 月已累计实现销售 100 腔。
封测设备⑨:TSV 镀膜设备
TSV 镀膜设备简介:
TSV 硅通孔刻蚀完成后,需要依次进行介质层沉积、阻挡层沉积、种子金属物理气相沉积、金属电镀,以形成具备完整电气性能的 TSV 结构
2.TSV 镀膜设备概览
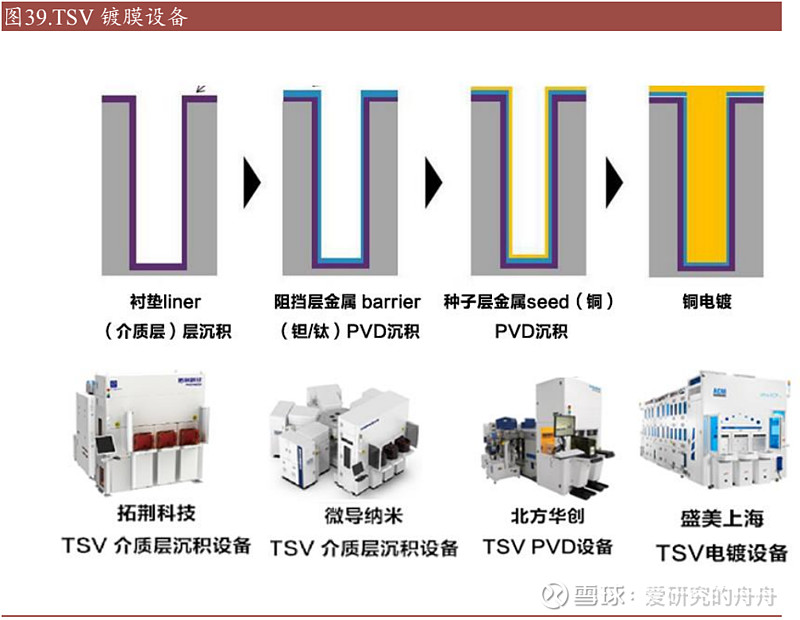
3.相关公司
拓荆科技的 PF-300T Astra 设备,微导纳米的 iTomic 设备,可用于硅通孔中介质层的沉积。北方华创的 PVD 设备用于硅通孔种子金属层/阻挡层沉积; 盛美上海公司的电镀机可用于 TSV 金属电镀工艺。全球范围内,TSV 介质层的 CVD 沉积设备主要由 AMAT/LAM/SPTS(KLA)等公司提供;PVD/电镀设备主要由 AMAT/SPTS(KLA)等公司提供。
封测设备⑩:封装用量检测设备
封装用量检测设备简介:
中后道封装作为关键环节,需要配套的量检测设备以保障良率。这些设备用于检测先进封装工艺中的凸点、硅通孔等结构的缺陷物残留,并测量这些结构的尺寸和间距。因此,新型封装检测设备采用红外线/X 射线等穿透能力强的技术路线,以强化对多层复杂结构的成像能力。
封装用量检测设备概览

相关公司
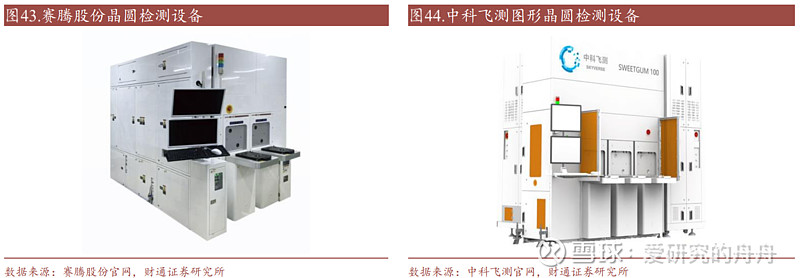
KLA-Tencor、Rudolph、Camtek 等公司为先进封装量检测设备领域的传统优势企业。赛腾股份通过收购全球领先的晶圆检测设备供应商日本 OPTIMA 涉足晶圆检测装备领域,部分产品具备晶圆背面检测能力,可用于先进封装领域,三星为其优质客户。中科飞测的晶圆三维形貌量测设备、图形晶圆缺陷检测设备可用于先进封装领域,封装领域客户包括华天科技、通富微电、长电科技。
封测设备11:其他设备
其他设备包括负责印刷助焊剂并放置锡球的植球机,负责对焊锡膏进行热处理,从而让贴装元器件和 PCB 焊盘通过焊锡膏合金可靠结合的回流焊炉(劲拓股份生产);负责切割引线框架分离芯片,并将外引脚压成预定形状的切筋成型机;负责在封装好的芯片顶部打印信息标示的激光打标机等。
风险
封装设备需求不及预期:
封装测试企业及晶圆厂的资本开支,决定封装设备的市场需求。2024 年全球半导体市场景气度复苏存在不确定性,可能导致封装设备需求不及预期,拖累相关公司业绩。
封装设备技术研发不及预期:
封装设备,尤其是先进封装设备存在较高的技术和验证壁垒,需要下游封测厂商与晶圆厂密切配合,新产品的研发进度存在不确定性;若研发验证或客户导入进度慢,可能会对相关公司的业绩造成不利影响。
行业竞争加剧:
有多家国内企业从事封装设备的研发与生产工作,若行业竞争加剧,封装设备的毛利率水平可能下滑,影响企业盈利能力。
免责声明:仅做知识整理,内容来自公开信息。本人对这些信息的准确性和完整性不作任何保证。投资有风险,入市需谨慎。且本材料不构成任何投资意见,请谨慎选择与自身风险承受能力、投资目标等相匹配的产品及服务。