
全球芯片制造商在扩展和改进先进封装技术方面的投入已达数十亿美元。他们坚信先进封装对于提高半导体的性能至关重要。
*1
三星宣布投资400亿美元用于在美先进封装芯片制造
三星近日宣布,投资400亿美元用于在美国德克萨斯州进行芯片制造,其中包括一项建设先进封装工厂的计划,这一计划将大大促进美国实现本土制造领先人工智能芯片的步伐。三星的这一举动被视为是拜登政府的重大胜利。与中国政府一样,美国政府也意识到了先进封装在半导体供应链中的关键作用。
什么是先进封装?
随着芯片小型化进程开始达到其物理极限,芯片制造商被迫寻找其他方法来持续提高性能,以满足生成式人工智能等技术日益密集的计算需求。
通过将多个芯片,无论是同类还是不同种类的芯片,更紧密地集成或“封装”在一起,芯片制造商能够提高速度和效率,同时规避小型化的限制。
先进封装示例
高带宽内存 (HBM):英伟达的图形处理单元 (GPU) 等高性能芯片需要大量内存来存储计算结果。即使是最先进的存储芯片本身也无法提供足够的“带宽”来根据需要存储和来回发送计算结果。高带宽存储芯片可以将DRAM存储芯片堆叠起来,并用穿过每层小孔的细线把它们连接起来;就像一个多层图书馆,通过电梯在楼层之间快速运输大量书籍以进行收集和交付。
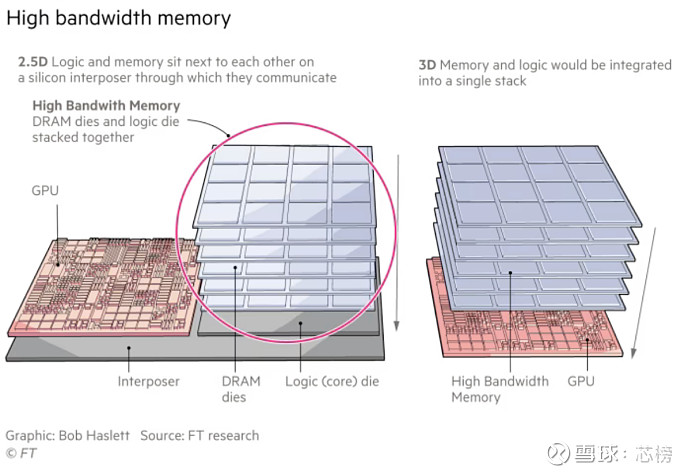
基板上晶圆芯片 (CoWoS):以英伟达的H100 Hopper AI芯片为例,它由六颗HBM芯片和英伟达设计、台积电生产的GPU集成,并采用台积电的CoWoS先进封装技术封装。GPU和HBM芯片都位于称为“中介层”的硅界面上,并通过该中介层相互通信,中介层又位于基板之上。台积电的竞争对手三星和英特尔也提供类似的先进封装技术。
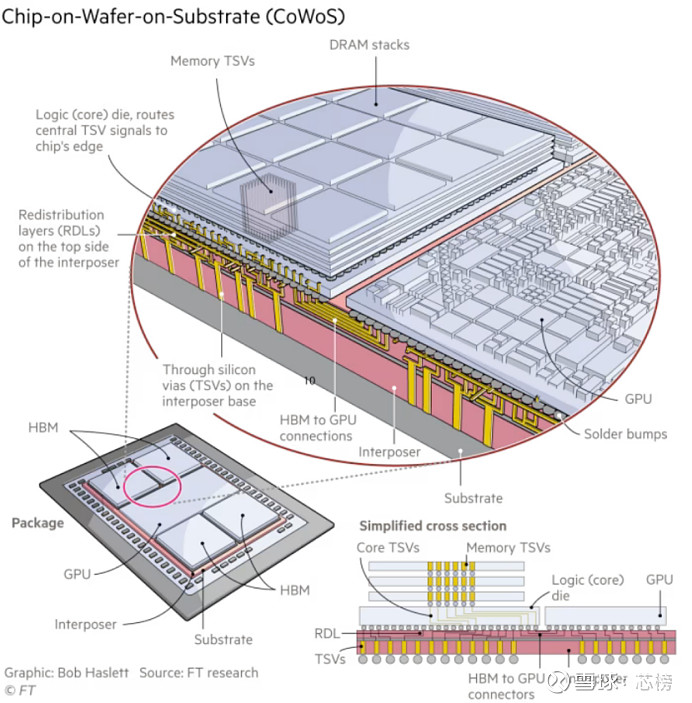
这种封装技术有时被称为“2.5D”先进封装技术,因为当HBM中的DRAM层层堆叠时,HBM芯片又与GPU并排放置。三星位于德克萨斯州的新工厂将具备2.5D和HBM封装能力,而韩国芯片制造商 SK海力士也正在美国印第安纳州建设HBM工厂。“3D封装”则涉及HBM和GPU组件的垂直集成,工程师们尚在研究如何保持这类系统的充分冷却以及供电。
集成扇出型(InFO)封装:当芯片受限于严格的物理限制时,先进封装也会非常有用。例如智能手机中的芯片,逻辑芯片不能变得更小了,而智能手机也不能变得更大。2017年,台积电与苹果合作推出了一种名为集成扇出型 (Integrated Fan-Out) 的先进封装技术。它通过新的高密度“重分布层”将逻辑芯片和存储芯片更紧密地集成在一起,在提高性能的同时消除了对更厚基础层的需求。
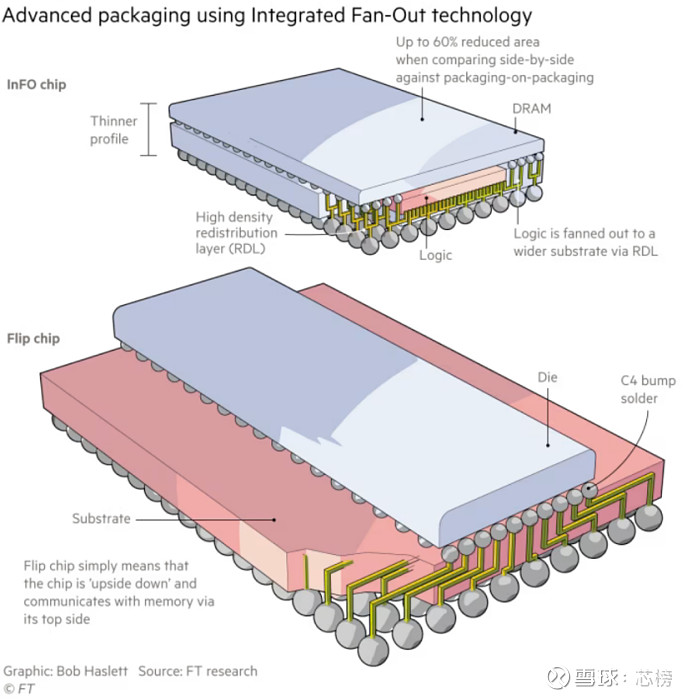
(本段文字请忽略)16C,可同时兼容砂浆线与金刚线应用,主要用于切割碳化硅、氮化镓、蓝宝石等高硬脆材料,适用于6″- 8″的大尺寸碳化硅晶片的高效切割应用。
先进封装对行业有何影响?
先进封装需要行业专家之间的紧密合作。
举例来说,没有存储芯片生产背景的台积电,与没有逻辑芯片生产背景的HBM市场领导者SK海力士密切合作,致力于开发英伟达的人工智能芯片。而三星和英特尔在逻辑芯片和内存芯片以及先进封装方面都有建树,这意味着他们将有可能为客户提供跨三个领域的集成服务。
先进封装的重要性越来越显见,这为二线芯片制造商和传统封装公司也创造了机会。这些公司也在投资自己的先进封装能力,以在5000亿美元的半导体市场中分得更大的蛋糕。
*2
英特尔与14家日本公司合作开发新技术以实现半导体封装自动化

《日经新闻》报告显示,美国和日本正在寻求降低其半导体供应链的地缘政治风险。英特尔计划与14家日本公司合作,致力于自动化“后端”芯片制造工艺技术,例如先进封装。该计划涉及的公司包括电子产品制造商欧姆龙、雅马哈汽车以及材料供应商Resonac和Shin-Etsu Polymer,并将由英特尔日本业务负责人Kunimasa Suzuki领导。
这个新团队将投资数百亿日元(1000万日元约等于6500万美元左右),力争在2028年提供可用技术。《日经新闻》报道称,随着包括电路形成在内的前道工艺趋近其物理极限,后端工序中的竞争正不断酝酿,例如堆叠芯片以提高性能。
英特尔领导的这个新集团将在未来几年内在日本启动一条后端生产线,目标是实现完全自动化。该公司还在研究后端技术的标准化,让制造、检查和输送设备全部由单一系统管理并控制。
据日本经济产业省称,日本市场对英特尔乃至全球市场都很重要,日本企业合计占据全球半导体生产设备约30%的份额,在半导体材料领域占据50%的份额。
《日经新闻》报道称,期望后端自动化能够弥补日本“芯片工程师的短缺”,因为台积电等大厂正在吸纳所有的优秀芯片工程师。