早年,苹果iPhone处理器一直是三星的禁脔(luan:禁止别人染指的肉,比喻某种珍美的,仅独自享有,典故源自晋元帝时,《世说新语·排调》上的记载----百度百科),但台积电却能自2016年以后,成为苹果“A系列”处理器的独家供应商,从iPhone 7 A10 到iPhone 11 A13,其中A10是16nm工艺,A11是10nm技术,A12是7nm工艺,A13是7nm+EVU技术,按道理说,7nm+EUV也是三星掌握的技术,苹果为何偏偏选择台积电?关键之一,就是台积电开发的全新封装技术CoWoS以及InFO,简单来说就是将LOGIC芯片和DRAM芯片放在interposer上,然后封装在基板上(Chip On Wafer On Substrate)。
再说点苹果处理器的历史,2013年量产的用于iPhone 5s的A7处理器由三星代工,黑色树脂里面,采用的是超薄PoP(Package On Package)封装,直接将一颗1GB的DRAM与处理器叠在一起封装。三星是目前唯一可以量产DRAM和处理器的公司,也拥有自营的封测厂,由它来代工,整个A7处理器在一个屋顶下完成,在成本、整合上拥有巨大优势。
这个时候台积电导入了CoWoS技术,理论上可让处理器减掉多达70%的厚度。由于三星Galaxy系列智能手机对苹果手机威胁越来越大,同时苹果也想摆脱对三星的依赖,台积电这个时候对CoWoS技术做了简化,降低了成本,设计出了InFo封装技术满足苹果需求,2016年11月一举拿下苹果iPhone 7订单,此后到现在一直通吃苹果订单。讲完背景知识,下面给大家介绍CoWoS技术细节。
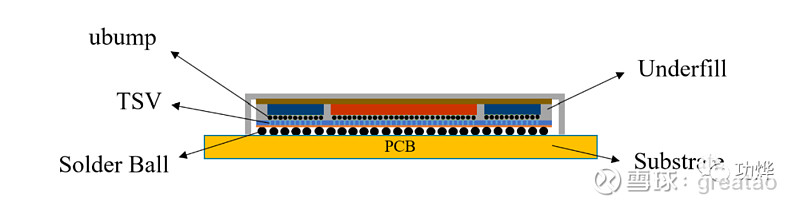

CoWoS(Chip On Wafer On Substrate)是一种2.5维的整合生产技术,先将芯片通过Chip on Wafer(CoW)的封装制程连接至硅晶圆,再把CoW芯片与基板(Substrate)连接,整合成CoWoS。
台积电2012年就开始量产CoWoS,通过这种芯片间共享基板的封装形式(没错,芯片中的共享概念2012年就开始了),台积电可以把多颗芯片封装到一起,平面上的裸芯片通过一种Silicon Interposer互联,达到了封装体积小,功耗低,引脚少的效果。
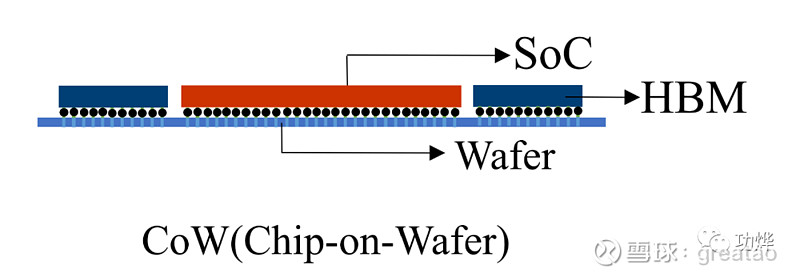
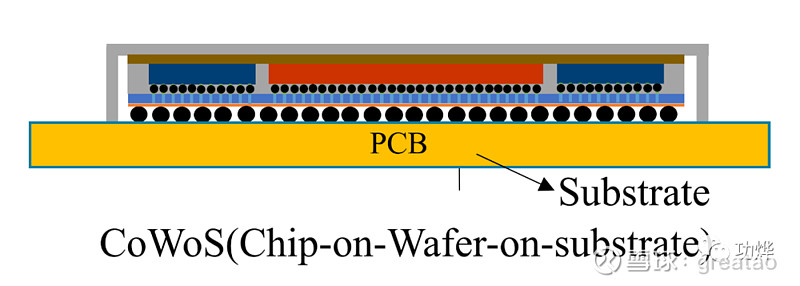
CoWoS process Flow如下:
1)先将芯片通过Si interposer与下面的wafer堆叠在一起,其中连接部分叫ubump,是一对Cu piller中间焊Solder,填入underfill保护芯片与连接的结构。
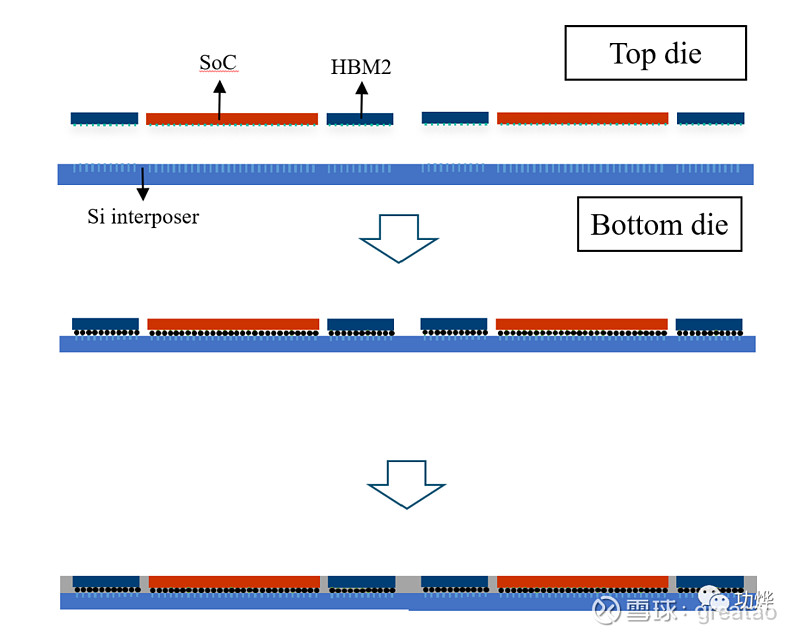

2)将芯片连接在载板上,然后进行CMP将Si interposer减薄,接着加入RDL与Solder ball。
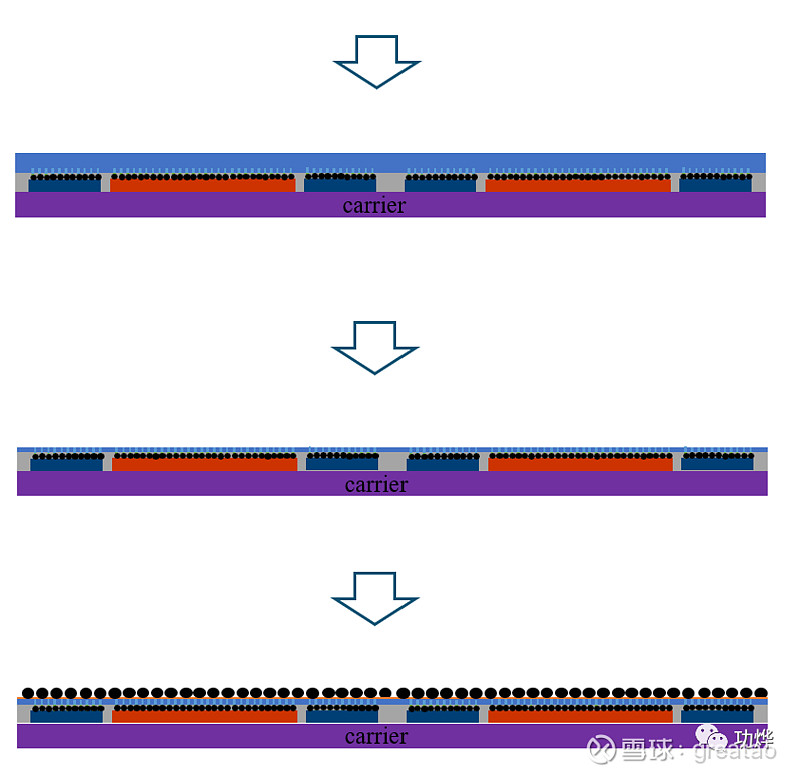
3)将wafer从载板上转移到胶带上,切割wafer,将芯片从胶带上取下来倒置安装在基板上。
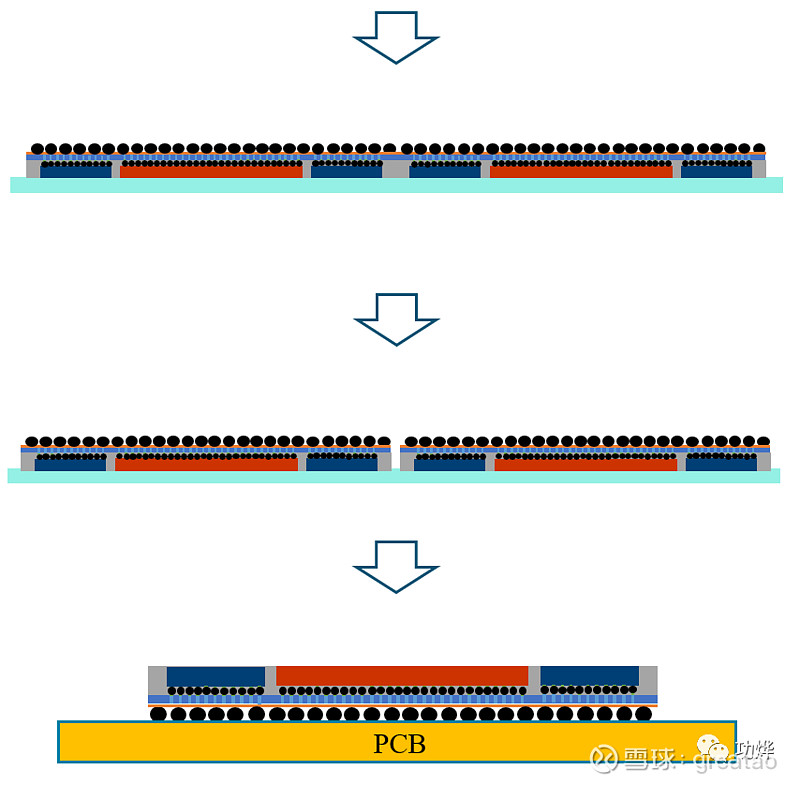
4)最后加上保护结构并使用热界面金属(TIM)填充保护盖与芯片中间的空隙
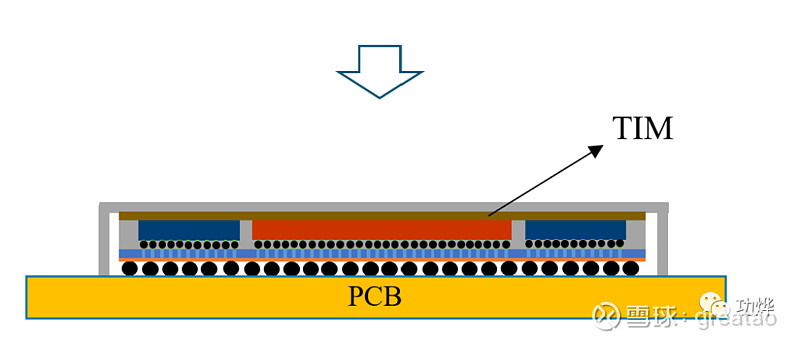
其实CoWoS技术应用很广泛,英伟达的GP100、战胜柯洁的AlphaGo背后的Google芯片TPU2.0都是采用CoWoS技术,人工智能AI火的背后其实也是靠CoWoS。
后台回复“台积电”,下载更多关于CoWoS的技术资料


长按 识别图中二维码即可关注
