
HBM(High Bandwidth Memory)是一种用于高性能计算和高带宽数据存储的存储器。HBM通过在DRAM芯片之间堆叠并封装在一起,形成大容量、高位宽的DDR组合阵列,以提高数据传输速率和减少能耗。HBM与GDDR都属于图像DDR中的一类。图像DDR一般使用在显卡上。对于算力或显像要求较高的场景,一般都会使用HBM,比如在AI服务器里搭配算力芯片GPU使用。
目前HBM主要供应的三大原厂为SK海力士、三星、美光。SK海力士预计到2030年HBM出货量将达到每年1亿颗,而2023年出货仅为50万颗。

图片来源:SK海力士
HBM井喷式发展,是投资长逻辑,分为不同阶段演绎:
◎第一阶段:海外原厂大幅扩产,IDM模式做HBM die+TSV+micro bumping,封锁技术。对应国内受益标的较少。
◎ 第二阶段:国内存储厂突破出货,补全AI芯片的存力版图,带动国产封测环节、设备、材料受益。
2023年三大原厂合计HBM 12寸晶圆产能约24万片/月,预计24年底将扩至70+万片/月。HBM目前由于供不应求,处于量价齐升阶段,预计随着产能释放,量升价平至量升价跌。
◎ 量升来自2个方面:随着AI芯片出货量提升,单颗GPU围6-8个HBM;HBM自身堆叠层数更高——平均一个HBM有4、6、8层,未来12层,极限可达16层。
◎ 价格趋势:目前HBM1到HBM3价格从~15到26美元/GB,HBM3e ~30美元/GB。
目前,HBM扩产瓶颈在设备投资和产品开发,设备投资包括光刻机,TSV设备, HKMG(high k metal gate)设备。HBM的TSV刻蚀是深反应刻蚀(vs.普通存储用等离子刻蚀),从背面一直打孔到正面,深宽比超过80:1,采用ICP(等离子单法刻蚀机),海外供应商如应材和泛林Lam。更难的是打孔后需要做种子层(沉积阻挡层),采用PVD设备,海外供应商主要是KLA等。电镀设备的提供厂商包括东京电子、应用材料、Lam等。
HBM是通用标准, 但各家的制程、TSV技术处理不一样,导致和SoC做适配时表现不一样。

数据来源:2023年12月3日存储行业专家访谈,丹羿投资
那么,HBM相较传统DDR5的制造过程主要变化有哪些?相对应地,我们该如何寻找投资机会?
封测环节是核心变化:
相比于DDR,HBM工艺的核心变化在于封测。HBM小部分变化在前道,差异主要为microbumping, TSV留出线路。主要变化在后道,每家封装方法不一样,包括TSV打孔和MicroBumping微球凸,之前这两个工艺主要用在逻辑芯片,但逻辑芯片中也没有HBM这么高深宽比。投资机会方面,关注国内封测厂商的技术和产品突破进展。
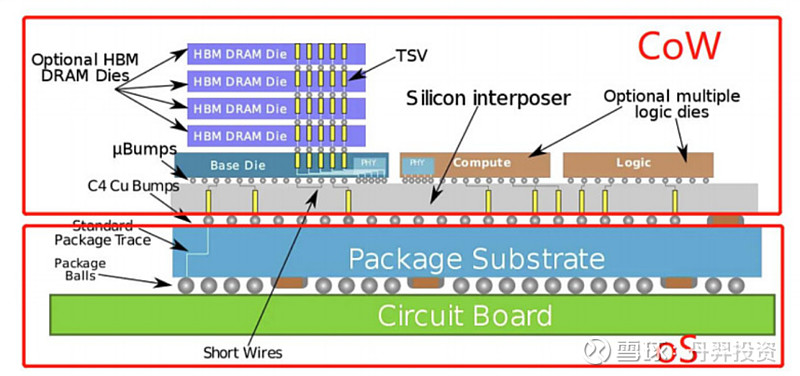
材料环节的变化:
◎ 前道材料:HBM材料用量和DDR单位晶圆的用量基本是一样的,包括前驱体、光刻胶等,国内相关标的有雅克科技等。
◎ 后道材料:HBM是多层堆叠,EMC用量是DDR的数倍。DDR用粉末EMC或者圆柱形,HBM由于每层之间距离很小,需要GMC,国内相关标的有华海诚科、联瑞新材等。
设备环节:
◎ 晶圆检测环节,除了对xy方向的抽检,HBM需要对侧面/z高度进行检测。国内赛腾股份收购日本OPTIMA做半导体量检测设备,供应海外原厂。
END
