如需原文档,请登陆未来智库www.vzkoo.com,搜索下载。
1. 2019 年前三季度电子行业市场表现回暖
2020 年,5G手机放量在即。2019 年下半年起,5G 手机逐步亮相,5G 手机出货量 将小幅提升,但由于存在一定普及时间,对整体换机影响不大。据 IDC 预测,2019 年全球 5G 手机出货量约为 670 万部。2020 年,随着大量 5G 手机正式问世,5G 机 型渗透率将显著提升,5G 手机将迎来喷井式爆发。据 IDC 预测,2023 年全球 5G 手机出货量将达到 4.013 亿部,较 2022 年上涨 23.9%。2019-2023 年,全球 5G 手 机渗透率将由 0.5%提升至 26.0%,全球 5G 手机出货量的 CAGR 将达到 178.19%。

2. 5G 进入成长期,关注六大增量领域
2.1. 5G 基站进入高速建设期,高端 PCB 板溢出效应依然明显
PCB(Printed Circuit Board),中文名称为印制电路板,是重要的电子部件,是电子 元器件的支撑体,是电子元器件电气连接的载体。按照下游应用可以将 PCB 细分为 通信用板、消费电子用板、计算机用板、汽车电子用板、航天航空用板、工控医疗 用板等。根据 Prismark,全球 PCB产值 2018-2022 年的复合增速约为 2.95%,其中 通讯板的需求在 2018-2022 年的复合增速有望达到 3.5%,主要是受益于 5G 基站的 建设。

5G 进展顺利,三大运营商纷纷推出具体建设计划。按照工信部的部署,我国将于 2020 年实现 5G 商用计划,为此,三大运营商都推出了具体的建设计划:中国移动 预计 2018-2019 年,逐步扩大试验规模,从五大城市扩大到 N+X 城市,站点规模达 到百站/城市,形成端到端的商用产品和预商用网络,2020 年达到全网万站规模; 中国联通已公开表态 5G 网络将以独立组网(SA)为目标构架,目前已陆续在 16 个城市开通 5G 规模试验,预计 2019 年试商用,2020 年正式商用;中国电信已明确优选独立组网(SA)方式部署 5G,计划于 2019 年实现 5G 试商用,2020 年实现 重点城市规模商用。

5G 基站建设推动通信 PCB板量价齐升。量:5G 基站数量提升较为明显,预计 5G 宏基站数量有望达到 4G 基站数量的 1.5 倍; 5G 宏基站结构变化推动 PCB使用面积 得到大幅度提升,价:数据处理能力要求得提升推动高频高速材料渗透率不断提升, PCB 价值量提升。

供给小于需求,同时利好一二线 PCB厂商。需求侧:2020 年基站 PCB需求高景气, 预计基站 PCB出货量增长三倍,我们预计 2020 年基站 PCB市场空间将超过百亿规 模。供给侧:国内通信 PCB厂商订单饱满,逐步进入拉货高峰阶段。通信 PCB 技 术含量相对较高,从新建产能到进入设备商供应体系需要较长时间成本,同时受环 保、投资资金量较大等影响,预计未来 PCB 行业依然是供给决定的市场。一线通信 PCB厂商深南电路、沪电股份和生益科技具备生产高频高速 PCB和高多层 PCB的 技术能力,形成一定的技术和产能壁垒。在高端 PCB产能紧缺且设备商急需交付订单的情况下,预计高端 PCB产品可以在中短期内维持高毛利率。通信 PCB 第二梯 队厂商景旺电子、崇达科技等已有产能布局,将享受 5G 基站建设的订单红利。此 外,PCB 上游高频覆铜板厂商生益科技有望充分获益 5G 基站建设。目前,国内掌 握高频材料的厂商不多。生益科技正在建设年产 150 万平米的高频板生产线,凭借 着高性价比逐步实现对美国罗杰斯的替代。
2.2. 天线材料 MPI 先行,射频前端关注国产替换机会
Sub 6GHZ 以上的 5G 信号需要高频传输,LCP 为大势所趋。LCP 材料介质损耗 与导体损耗更小,同时具备灵活性、密封性,因而具有很好的制造高频器件应用前 景。所以在 5G 时代高频高速的趋势下, LCP 将替代 PI 成为新的软板工艺。苹果 2017 年发布的 iPhoneX 首次采用了多层 LCP 天线,iPhone X 采用的 LCP 软板有一段细 长线,将 WiFi 天线、蜂窝天线与主板相连,起到传递射频信号的作用。2018 年新 发布的 iPhone XS/XS Max/XR 均使用了六根 LCP 天线。但由于 LCP 单机价值较高, 因此今年 iPhone 11 采取 LCP+MPI 方案压低整体成本。
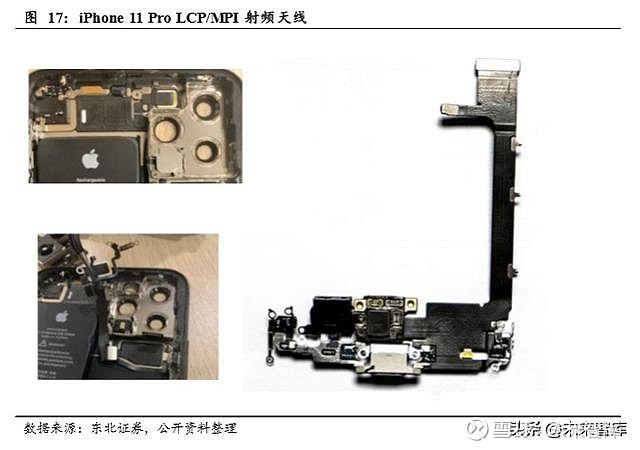
MPI 即改性 PI,是 PI 的一种改进方案,依旧采用 PI 作为基板做成的 MPI 软板。 由于 MPI 是非结晶性材料,所以操作温度款,在低温压合铜箔下易操作,表面能够 与铜较易接着,价格相对较低。MPI 软板的介电常数和传输消耗都介于 PI 软板和 LCP 软板之间,在中低频段性能与 LCP 几乎相同,且价格相对更便宜。因此在 Sub 6 GHz 频段下,MPI 仍可以被广泛使用,因此被当做是 Sub 6GHz 到毫米波的过渡 方案。未来随着 5G 毫米波的出现,LCP 材料将成为传输信号的最优之选。重点推 荐 LCP、MPI 模组厂商立讯精密、鹏鼎控股、东山精密。

Sub 6GHz 下,LDS 依旧是安系主流方案。LDS 天线技术为激光直接成型技术,利 用计算机按照导电图形的轨迹控制激光的运动,将激光投照到模塑成型的三维塑料 器件上,在几秒钟的时间内,活化出电路图案。苹果公司从 iPhone 6 开始采用 LDS 天线,在金属后盖上注塑,将金属后盖被切分成三段。与传统的天线的相比,LDS 天线性能稳定,一致性好,精度高,并且由于是将天线镭射在手机外壳上,不仅避 免了手机内部元器件的干扰,保证了手机的信号,而且增强了手机的空间的利用率, 满足了智能手机轻薄化的要求。

但由于金属后盖对信号接受仍有影响,玻璃背板开始大规模使用,随着玻璃背板渗 透率的提高,LDS 天线移至手机内部塑料板上进行通信信号的接受。我们预计明年 5G 手机将主要以安卓手机为主,在 Sub 6GHz 的频段下,考虑到成本和设计方案的 因素,LDS 天线方案将依旧是手机厂商的最优选择。

5G 时代势必带来天线市场规模的提升。根据中国产业信息网统计,随着 5G 手机渗 透率的提升,5G 手机天线将呈现爆发式增长态势,2022 年将达到 352 亿元。重点 推荐 LDS 天线龙头企业信维通信。

5G 时代射频前端规模大幅增加,国产替代趋势明确。射频前端(RFFE)是智能手 机的射频收发器和天线之间的功能区域。一般而言包括功率放大器(PA:Power Amplifier), 主要用于实现发射通道的射频信号放大;天线开关(Switch),主要用 于实现射频信号接收与发射的切换、不同频段间的切换;、滤波器(Filter),主要用 于保留特定频段内的信号,而将特定频段外的信号滤除;、双工器(Duplexer 和 Diplexer),主要用于将发射和接收信号的隔离,保证接收和发射在共用同一天线的 情况下能正常工作;低噪声放大器(LNA:Low Noise Amplifier)等器件,主要用 于射频低噪声放大器用于实现接收通道的射频信号放大。随着手机的频段不断增 加,智能手机需要接收更多频段的射频信号,5G 单个智能手机所需的射频开关、PA、LNA、滤波器、双工器等数量将显著上升,未来全球射频前端市场规模将迎来大规 模增长。

5G 频段增加推动射频前端市场规模扩大。根据 Yole 的预测,2023 年射频前端的市 场规模将达到 350 亿美元,较 2017 年 150 亿美元增加 130%,未来 6 年复合增速高 达 14%。其中,以开关和 LNA 为例, 2011 年及之前智能手机支持的频段数不超 过 10 个,而随着 4G 通讯技术的普及, 2016 年智能手机支持的频段数已经接近 40 个;因此,移动智能终端中需要不断增加射频开关的数量以满足对不同频段信 号接收、发射的需求,推动整个射频前端市场规模。
根据 QYR Electronics Research Center 的统计,2010 年以来全球射频开关市场经历 了持续的快速增长,2016 年全球市场规模达到 12.57 亿美元,2017 年及之后增速 放缓,但预计到 2020 年期间仍保有 10%的增长率,预计到 2020 年达到 18.79 亿 美元。而随着移动通讯技术的变革,移动智能终端对信号接收质量提出更高要求, 需要对天线接收的信号放大以进行后续处理。一般的放大器在放大信号的同时会引 入噪声,而射频低噪声放大器能最大限度地抑制噪声,因此得到广泛的应用。2016 年全球射频低噪声放大器收入为 12.80 亿美元,而随着 4G 逐渐普及,智能手机 中天线和射频通路的数量增多,对射频低噪声放大器的数量需求迅速增加,因此预 计在未来几年将持续增长,到 2020 年达到 14.75 亿美元。

Mate 30 Pro 5G 手机分立器件增多,LNA/RF 开关芯片大幅增加。根据 Techinsights 拆解的 Mate 30 Pro 5G 手机,可以发现国产替代大环境下,芯片多采用自研或者采 购于非美系厂商。集成度重回 Mate 8 时代,因此 LNA/RF 开关更多分离出来作为单 独的芯片封装在主板上,量明显增多。除此之外,未来随着 5G 毫米波频段的增多, LNA 和 RF 开关数量有望进一步提升。重点推荐国内 LNA、RF开关龙头企业卓胜 微。

2.3. SLP、SiP、小尺寸元器件三大方案助力 5G 终端持续小型化
5G 场景下,手机终端需要配备更多的射频模组。5G 向下兼容 4G、3G、2G 等制式, 无论是独立 BP(Baseband processor)方案还是 AP(Application processor)集成 BP 方案,同一制程下芯片组的面积一定是变大的。独立 BP 占用了更多的主板区域; AP 集成 BP 则增加了 SoC 的面积。对于手机终端本就有限的空间而言,5G 时代提 出了更为严苛的挑战,而 SLP、SiP、小尺寸元器件三大方案,将助力 5G 终端持续 小型化。
摩尔定律失效,芯片尺寸不再满足“每 18 个月尺寸缩小一倍,或单位面积晶体管数 量翻倍”。移动终端设备体积有限,但其内堆叠的各类元器件却始终在增加,芯片尺 寸难以一再缩减,最现实的解决方案即为将各元件排布更为紧密。
2.3.1. SLP 填补 PCB 与封装基板间的空缺
通常而言,PCB板能做到的电路线宽/线距(L/S)在 30/30 um 以上,芯片封装基板 Substrate 的 L/S 在 25/25 um 以下。L/S 决定了各元件间的间距。L/S 越小,各元件 就能排布得更紧密。
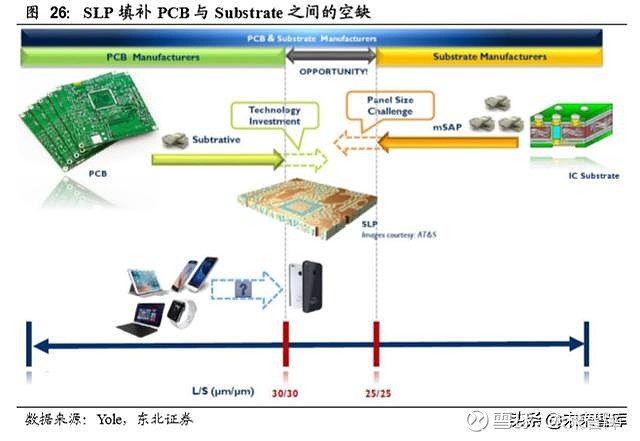
封装基板 Substrate 的优势是 L/S 小,但缺点明显,即 Substrate 的尺寸受限,现有工 艺下难以做到大尺寸,比如很难做到 100 mm 以上,且成本远远高于 PCB。因此, 现阶段 Substrate 还不能替代 PCB作为承载所有元件的电路主板。
PCB的优势是工艺成熟(Subtractive 工艺),很容易做到大尺寸,且成本比 Substrate 低,但缺点在于 L/S 大,难以实现小型化和超高密度 SMT(贴装)。
SLP,即 Substrate-like PCB(类载板型 PCB) ,则兼顾了 Substrate 和 PCB的优点: L/S 小,可以做大尺寸,且成本适中。因此,SLP 被广大手机终端厂商看重,寄希 望于通过 SLP 实现 IC小型化,释放更多的体积空间以及集成更多电子元件。作为 主板元件,除了更小的 L/S,SLP 比 PCB 更明显的优势是在于可以堆叠。更小的 L/S 是从二维横向去提高面积的利用,而 SLP 堆叠则可以提高三维纵向的空间利用 率。Apple 在 iPhone X 以及 iPhone X 中采用了平面型的 SLP 作为 IC 主板,在今年 发布的 iPhone 11/11 pro/11 pro max 中使用了堆叠型的 SLP,大大减少了手机内部 IC 主板横向占用面积,为电池提供了更多的空间(电池容量从 iPhone Xs 的 2658 mAh 提升到 iPhone 11 pro 的 3322 mAh,提升幅度达 25%)。
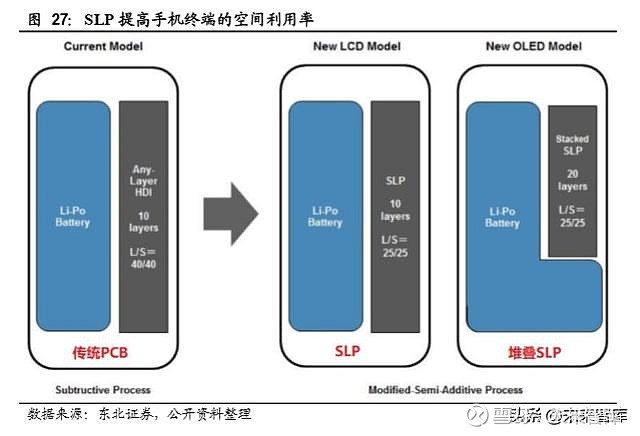
2.3.2. SiP 将多元件整合模块化
SiP 最主要的作用是在于整合各个分立的元件,使之协同工作。从外观和功能上看, SiP 封装后的模组可视为一颗独立和完整的芯片。
与 PCB主板相比,SiP 模组用的载板,其 L/S 更小,可以集成更多的元件。SiP 目 前有两种应用方案,一种是将整个 IC 主板 SiP化,苹果的 apple watch 以及 airpods 即采用该方案;另外一种是将相关元件模块化集成在 SiP封装中,然后作为独立的 模组或芯片,再贴装到 PCB 主板上,华为 Mate 30 5G 版本中的 Power management 模块、LNA/RF Switch 模块等均采用 SiP 封装后再贴装到手机主板。理论上,麒麟 处理器采用的 PoP 封装,将 AP 与 Memory 合封为一体,也属于 SiP 范畴。
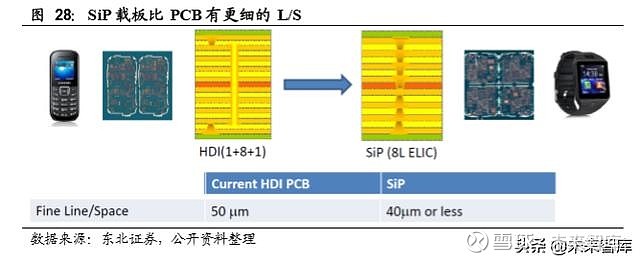
SiP 另一个作用在于模组化后再布线,将 I/O 重新分配,以实现更合理的信息互连。 如果没有 SiP 基板将各个元件之间的线路连接再次布线,而是将各元件直接装配到 PCB 主板上,主板线路设计更为复杂,加之 PCB 主板的 L/S 更宽,整个贴装将会占用更大的空间。
2.3.3. 元器件小型化是大势所趋
随着手机及电子产品以轻薄短小、多功能及高整合为诉求,使用表面贴装型(SMD) 的产品需求与日俱增,器件数量都在增加,有限的空间只能容纳更小封装的电子器 件,对应需要的元器件尺寸也大幅缩小。目前市场上电容、电感、电阻等主流使用 型号为 0201、0402、0603、0805、1008、1206、1210 等产品,未来将朝着更小的 尺寸及更高精度发展。以电感为例,代表目前全球最先进片感制备工艺的是村田于 2016 年 8 月量产的超小 008004 尺寸(0.25×0.125mm)的射频电感器“LQP01HQ 系列”,样品价格 5 日元个。


2.4. 算力提升功耗加大,电源管理及散热成 5G 刚需
5G 手机因为应用功能变多,电池续航、功耗成为不可忽视的问题。5G 手机应用场 景广泛,手机厂商提高电池续航的方法主要为(1)提升电池容量,和(2)快充功 率变高。目前市面上 5G 手机的电池容量普遍在 4000 毫安以上,而安卓代表机型华 为 Mate 30 Pro 5G 和三星 S10 5G 手机电池容量均为 4500 毫安, iPhone 11 系列作为4G 手机,电池容量也提升了 800 毫安至 3900 毫安。未来随着 5G 手机的普及,电 池容量的提升成为刚需。快充同样有着类似的增长曲线,随着手机机型的更新迭代, 快充瓦数也在不断地突破新高。19 年 4 月发布的三星 S10 5G 快充瓦数为 25W,19 年 9 月发布的 iPhone 11 快充瓦数为 18W, 19 年 10 月发布的华为 Mate 30 Pro 快充 瓦数为 40W。以华为 Mate 30 Pro 为例,40W 快充可以实现 30 分钟快速充电 70%, 极大提高了手机的使用时长。
电池容量增大带来体检的变大,芯片集成更加紧凑,散热成为当务之急。大容量电 池几乎都伴随着体积的相应增加。iPhone 和华为最新款手机都面临着电池体积增 大,其他零部件空间减少的情况。而空间的减少势必带来芯片集成度和封装程度进 一步提高。而芯片封装的越紧凑,散热越难。由于 iPhone 11 增加 U1 超宽带芯片, 叠加摄像头个数怎多,主板内部芯片更加紧凑,散热也更难。根据热量对比测试可 以发现,当在进行轻度负载测试(观看视频 30 分钟)后,iPhone 11 Pro Max 凭借较 大的散热面积表现良好;而中度负载测试(玩游戏 30 分钟)后,iPhone 11 Pro Max 发热情况仅次于“火炉”iPhone X,且摄像头下方有明显热感;极限条件下,iPhone 11 Pro Max 的峰值温度达到 48 度,摄像头周围发热现象显著,高于 iPhone X 以及 其他机型,同时其热源相比 Xs Max 有所下移。

苹果散热一直采用石墨片为主。石墨散热片的化学成分主要是单一的碳(C)元素,是 一种自然元素矿物.可以通过化学方法高温高压下得到石墨化薄膜,因为碳元素是非 金属元素,但是却有金属材料的导电,导热性能,还具有像有机塑料一样的可塑性,并 且还有特殊的热性能,化学稳定性,润滑和能涂敷在固体表面的等等一些良好的工艺 性能,石墨散热片平面内具有 150-1500 W/m-K范围内的超高导热性能。石墨片主 要具有以下几个特点:(1)表面可以与金属、塑胶、不干胶等其它材料组合,以满 足更多的设计功能和需要;(2)低热阻;(3)重量轻;(4)高导热系数:石墨散热 片能平滑贴附在任何平面和弯曲的表面,并能依客户的需求作任何形式的切割。
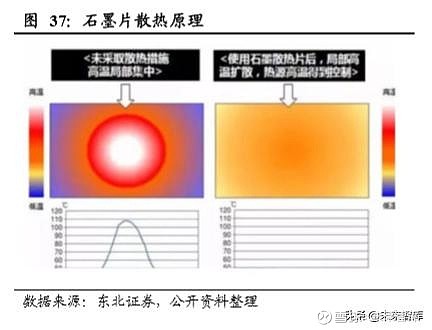
安卓系采用热管和均热板为主。由于安卓系 5G 手机布局更快,对散热的需求更加 紧迫。目前以三星华为为代表的安卓系 5G 手机均采用 VC(均热板)进行散热。相 比石墨片,均热板和热管散热效果更好。
均热板更轻薄,管是更适合 5G 机型的散热方案。VC(VaporChambers)即平面热管, 也叫均温板或者均热板,均热板是一个内壁具有微细结构的真空腔体,通常由铜制 成。当热由热源传导至蒸发区时,腔体里的冷却液在低真空度的环境中受热后开始产生冷却液的气化现象,此时吸收热能并且体积迅速膨胀,气相的冷却介质迅速充 满整个腔体,当气相工质接触到一个比较冷的区域时便会产生凝结的现象。借由凝 结的现象释放出在蒸发时累积的热,凝结后的冷却液会借由微结构的毛细管道再回 到蒸发热源处,此运作将在腔体内周而复始进行。热管和均热板的工作原理几乎一 样,但在传导方式上,热管是一维线性热传导而均热板则是将热量在一二维平面上 传导,相对于热管,首先均热板与热源以及散热介质的接触面积更大,能够使表面 温度更加均匀。由于均温版的面积较大,能够更好的减少热点,实现芯片下的等温 性,相较于热管有更大的性能优势,同时均温版还更加轻薄,在快速的吸收以及散 发热量的同时也更加符合目前手机更加轻薄化、空间利用最大化的发展趋势。
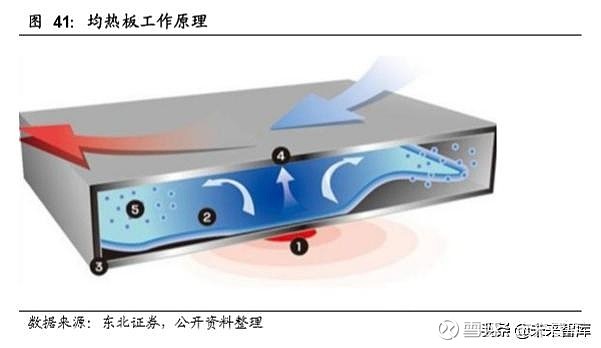
根据前瞻产业研究院预估,手机散热约占散热产业总规模的 7%,2018 年约为 100 亿元。虽然占比低,但是未来受益于 5G 智能终端持续升级的驱动,手机散热市场 有望保持高增长,2018~2022 年年平均复合增长率有望达 26%。重点推荐石墨散热 龙头、且在均热板、热管均有布局的中石科技。

5G 安卓系两款手机电源管理芯片数量明增多。电源管理芯片(Power Management Integrated Circuits),是在电子设备系统中担负起对电能的变换、分配、检测及其他 电能管理的职责的芯片。以手机为例,智能手机由许多不同功能的模块组成,每个 模块所需供电电压各不相同,由锂电池直接供电无法满足各模块要求,因此需要一 个高效率电源管理芯片,把锂电池提供的电压用不同方法按照需要进行转换和调 节,达到期望的电压值,以满足各个模块的需要。例如,存储类型等数字电路由于 受到制造工艺的限制,需要较低的供电电压;而模拟电路、射频电路和显示部分则 需要一个较高的供电电压。此外,电源管理 IC 还需要根据系统的工作状态信息动 态调节各个模块的供电电压值,实现优化控制,减小功耗,从而提高系统的效率, 缩小产品体积,降低成本。因此,电源管理 IC 已经成为电子产品系统设计中一个 最基本也是最重要的部分。5G 时代,算力提升,应用处理器、基带芯片及射频前 端将带来更大的功耗,除电池容量增大外,5G 终端电源管理也将是较大增量。对 比三星 S10 5G 和 4G 手机,电源管理芯片从之前的 6 颗提升至 9 颗,增量为 50%, 因此我们预计未来国内5G的安卓机型电源管理芯片也将维持一个50%左右的增长。
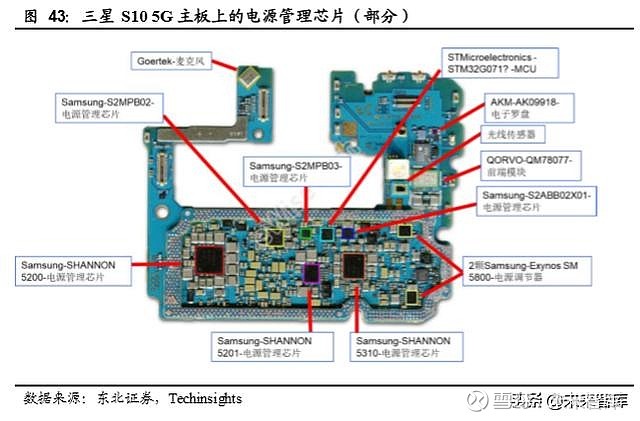
赛迪顾问数据显示,中国电源管理芯片市场 2015 年约 580 亿元,未来五年复合 增长率大约在 8.4%左右,到 2020 年中国电源管理芯片市场规模约为 860 亿元。 重点推荐国内电源管理芯片龙头企业圣邦股份。
2.5. 5G 视觉信息采集必备终端,关注渗透率大幅提升
智能手机存量时代,头部厂商市场集中度提升。根据 IDC 统计,智能手机销量自 2017 年开始为期两年的下滑,2017 年全球智能手机出货量为 14.65 亿台,同比下滑 0.5%,2018 年全球智能手机出货量为 13.95 亿台,同比下滑 4.8%。截止 2019 年上 半年,手机出货量为 6.44 亿台,同比下滑 4.8%。随着手机销量的下滑,拥有忠实 客户群体和品牌效应的手机大厂市场集中度进一步提升,截止 19Q2,前五大手机 厂商市占率为 69%,同比上升 2 个百分点。

光学创新是智能手机差异化竞争热点之一。智能手机行业近年集中度进一步提升, 各大品牌厂商均在努力挖掘差异化竞争的热点。光学领域创新是目前手机差异化竞 争的重要热点之一。无论光学结构如何变化,究其核心是在于追求光学器件尺寸的 小型化;性能规格的提升(高分辨率、大光圈、广角及 3D 应用等)。

摄像头模组与智能手机出货量变化趋势不同调,头部厂商积极布局多射。全球手机 摄像头模组数量受多射、3D 深度摄像头等光学创新因素刺激,出货量一直保持稳 定增长。2018 年 3 月华为 P20 Pro 搭配后臵三射横空出世,开启了从双摄到三摄的 时代,此后每半年推出的 Mate 20 Pro, P30 Pro 以及 Mate 30 Pro 均比同期上一代多 一颗摄像头。根据前瞻研究院数据显示,截止 2018 年,全球智能手机摄像头数量 为 41.5 亿颗,同比增长 6.33%,平均每部手机摄像头颗数为 2.84 颗,同比增长 6.77%。 而摄像头模组出货量与智能手机出货量增速呈相反方向,表明手机存量时代,光学创新依旧带动摄像头出货量逆势增长。

目前,前置和后置多射已成为 2019 年的主流机型。以目前驱动手机出货量的几大 头部手机厂商为例,截止 2019 年 10 月,大部分厂商机型搭配的摄像头总个数已超 过 2018 年全年数量。除了后臵多射的增加,前臵双摄在智能手机中也开始应用, 例如三星在 2019 年发布的 Galaxy S10+和 Galaxy Fold 折叠屏手机上均采用前臵双 摄模组,因此我们预计未来前臵双摄渗透率也将进一步提升。

随着 5G的到来,3D结构光技术、ToF 技术将加快与 AR领域的结合,3D sensing 摄像头渗透率将加速提升。2018 年 5 月 10 日,OPPO 在其召开的技术沟通会上指 出,利用精确的结构光双摄相机拍摄的三维信息,可以实现精确的 AR 贴纸与微表 情效果;在 AR 游戏应用方面,利用结构光对周围的环境进行精确 3D 建模并将模 型实时导入游戏中,可以实现虚拟游戏与现实三维世界的紧密融合,达到逼真的三 维效果。与此同时,OPPO R17 Pro 可以利用 ToF 精准探测景深信息,实现有趣且实 用的 AR 测量功能;华为旗下的荣耀 V20 则在 AR 测量以外带来了更多 ToF 玩法, 包括瘦身美体、大光圈拍摄、体感游戏等。
近年来,品牌手机逐渐加强对 3D 结构光技术和 ToF 技术的应用。2017 年 9 月 13 日,苹果推出了基于 3D 结构光技术的 iPhone X,以面部识别彻底取代了指纹识别; 2018 年 5 月 31 日,小米 8 周年代表作——小米 8 透明探索版正式发布,打造了全 球首款采用 3D 结构光技术的安卓手机;2018 年 6 月,搭载 3D 结构光技术的 OPPO Find X 发布;2018 年 8 月 23 日,搭载 ToF 3D 立体摄像头的 OPPO R17 Pro 发布; 2018 年 10 月 16 日,支持 3D 结构光人脸识别的华为 Mate 20 Pro 正式登场;2018 年 12 月 26 日,华为旗下搭载 ToF 立体深感镜头的荣耀 V20 正式发布,能够实现实 时的 3D 美体塑形和体感识别;2018 年 12 月 29 日,VIVO NEX 双屏版正式发布, 搭载 ToF 3D 立体摄像头的同时还支持 ToF 零光感人脸识别;2019 年 2 月,三星发 布了全球首款正式发售的 5G 智能手机三星 Galaxy S10 5G 版,增加了 ToF 传感器 以辅助散景拍摄和 AR 应用;2019 年 9 月,华为 Mate 30 Pro 发布,其前臵和后臵 3D 深感摄像头均采用了 ToF 方案。

窄带滤光片是 3D结构光技术和 ToF 技术的重要组成元件。窄带滤光片只允许在特 定波段的光信号通过,而阻止偏离该波段以外的两侧光信号。在 3D sensing 方案的 红外摄像头中(接收端),窄带滤光片能够使得接收端剔除环境光而只保留特定波 长的红外光;在 ToF 技术中,其红外摄像头接收端中也需要添加窄带滤光片来抑制 非相干光源,并防止传感器因外部光线干扰而过度曝光。
3D sensing 市场规模在 2020 年将加速增长。据 Trend Force 预测,全球 3D Sensing 市场规模将迎来爆发式增长,从 2017 年的 8.19 亿美元增加到 2020 年的 108.49 亿 美元。3D Sensing 在智能手机市场的渗透率将有大幅提高,由 2017 年的 2.1%升高 至 2020 年的 28.6%。重点推荐港股摄像头模组、镜头厂商龙头公司舜宇光学科技, 滤光片龙头企业水晶光电。

5G 网络下传输能力提升,高分辨率屏幕成为主流,倒逼手机主射像素持续提升。 中国移动发布的《5G 终端指导》显示,5G 体验速率超百兆,是 4G的 10 倍左右。 中国电信 2017 年底在雄安新区开展的 5G 试点现场测试,相较 4G 用户现有峰值体 验,5G 可提升约 20 倍。因此,在 5G 的网络环境下,视频表现的形式也将多样化, 高清视频除了有 5G 的软件支持,硬件方面上,4K、8K高分辨率屏幕渗透率也随着 需求逐渐上升。高清分辨率屏幕中的图像分辨率取决于图像的像素和尺寸,而手机 摄像头的像素代表了一部手机最大可拍摄的照片尺寸。以红米 Note7 使用的三星 S5KGM1 4800 万像素传感器为例,4800 万像素对应的传感器分辨率为 4000*3000, 目前 4K、8K分辨率为 3840*2160 和 7680*4320,且 4K、8K屏幕渗透率逐年提高。 随着 5G 网络的部署,高清影像的拍摄和显示成为核心关注点,高分辨率屏幕渗透 率的提高将倒逼前端拍摄端像素水平的提高,以达到高清画质输入、高清画质输出的无损画质观看体验。

主射分辨率是竞争硬指标,预计明后年 1 亿像素普及率将提高。据医学研究,人眼 的感光细胞主要是视杆和视锥细胞,视网膜里一共约有 600 万视锥细胞和 1.25 亿视 杆细胞,如果将感光细胞近似理解成像素点,据三星称人眼接近 5.76 亿像素水平。 三星表示,为了接近“所见即所得”的效果,目前单反相机的像素早已超过千万, 三星前期发布的“亮 HMX 图像传感器”的像素达到了 1 亿 800 万,传感器尺寸达 到了 1/1.33 英寸,像素尺寸达到了 0.8 微米。目前智能手机镜头的高分辨率主要集 中在 4800 万像素,机器拟人化仍将是趋势,作为视觉核心的摄像头将持续向人眼 极限挑战。因此手机镜头分辨率仍有提升空间。而另一方面,自手机配臵摄像镜头 以来,主射镜头的分辨率提升一直是行业关注的重要指标,也是手机厂商营销的重 要卖点,我们预计在未来这一趋势依然持续。
摄像头模组由镜头、VCM 马达、红外滤光片、CMOS 图像传感器等组成。拍摄景 物通过镜头,将生成的光学图像投射到传感器上,然后光学图像被转换成电信号,电信号再经过模数转换变为数字信号,数字信号经过 DSP 加工处理,再被送到手机 处理器中进行处理,最终转换成手机屏幕上能够看到的图像。因此摄像头模组需要 【镜头】收集光线然后将物体成像到图像传感器,镜头通常由几片透镜或塑料组成; 【图像传感器】是将表面的上镜头送过来的光信号转化成为电信号;【音圈马达】 的作用是推动镜头移动实现对焦,可以通过移动镜头得到清晰的照片; 【红外截止 滤光片】的作用是过滤掉多余红外光和紫外光,使得拍照出来的照片颜色更加接近 我们人眼所看到的颜色。对比人眼来看,CMOS 图像传感器相当于视网膜感光细胞; 镜头充当了一部分晶状体的功能。摄像头整体分辨率的提升,需要 CMOS 感光芯 片及采光镜头共同配合实现。

预计 1 亿像素以上需要至少 8 片以上塑料,良率、厚度、温漂及设计难度将进一步 困扰相关厂商。我们采用大立光的方案进行推算,其 4P 做到了 1300 万像素,5P 做到了 3200 万像素,6P 做到了 4800 万像素,以此估算 1 亿像素至少需要 8 片以上 塑料。随着塑料片数增多,会带来良率、镜头厚度、温漂及设计难度大幅提升等问 题,大立光在 7P 方案推出的节奏上明显放缓,预计难度更大的 8P 方案推进仍值得 关注。

玻璃材料具有更高的折射率及透光性能,工艺改善突破量产问题。从聚光能力来看, 玻璃材料相当于 1.5 至 2 片光学塑料,同时具有更好的透光性及环境稳定性,之前 困扰玻璃材料的量产问题,也通过引入模压成型等工艺得到一定程度的突破。在未 来对于光学性能要求更加苛刻、光学元件体积要求更小的大环境下,玻璃材料将更 具优势。
玻塑混合方案有望成为未来主要镜头方案之一。在全塑镜头基础上,引入玻璃镜片 可以实现更大光圈、中和塑料材料的温度影响以及减小镜头厚度的优势,在未来光 学元件小型化及分辨率提升的大趋势下,更具发展潜力。而对于市场比较关注的模 造玻璃量产问题,随着自动化程度及模具改造将得到解决。重点推荐玻塑混合龙头 企业联创电子。
2.6. 新终端拓展 5G 功能与场景,关注 VR/AR 发展良机
VR/AR 一直被视为笔记本、手机之后的下一代移动端计算平台,但是长久以来一直 不能上量,VR 行业在 2017 年甚至出现了衰退。除了应用生态端以及硬件端的逐渐 摸索,限制 VR/AR 成为移动端计算平台的最根本原因在于“移不动”。无论是当前 室内无线通信 IEEE 802.11 各标准,还是 4G 网速,均难以满足 VR/AR 对无线通讯 信息传输要求。复杂计算场景需求只能依托于有线传输。而 5G 到来,则可以解放 VR/AR 的线缆束缚,打开其成为移动端计算平台的潜力之门。
VR 产业复兴与 5G部署匹配且相互促进
在 2019 年 10 月 19 日的“世界 VR 产业大会”上,华为发布了关于 VR 的主题演讲。 华为认为,当前 VR 产业正处在复兴期,与 5G 产业高度匹配且相互促进。经历了 2017 年的产业低谷,VR 在 2018 年以后进入了产业复兴期。一方面,VR 显示规格 需求更为清晰,硬件形式也由“眼镜盒子式”逐步演变成“一体式 VR”;另一方面, 软件生态上,VR 应用也有了更多的积累。2019 年以后,5G 正式开始部署,与复兴 中的 VR 产业匹配而又相互促进。

5G 高传输、低延迟,摆脱线缆,匹配 VR 视觉要求,助力构建云端算力传输体系
VR 头显属于近眼显示,对于显示的要求极高。当前 VR 显示最核心的痛点在于用 户长久佩戴会有晕眩感。低分辨率和画面延迟都是产生晕眩感的原因。若要消除晕 眩感,VR 业界公认有三大指标必须满足:延迟低于 20ms、刷新率高于 75Hz、单 眼 1k 以的上分辨率。在 75Hz 刷新率和 H.264 压缩协议下,显示 1k 分辨率的 VR 内容需要 17.5 Mbps 码率,而 4G网络的码率仅为 10Mbps。因此,4G 网络下,VR 无法实现高分辨率高帧数的内容显示,只能依托于线缆进行显示数据的传输。相较 而言,5G 可以实现 100-1024Mbps 码率的传输。另外,4G 网络的延迟在~10ms 量 级,LCD 的响应时间最短可以到 8ms(OLED 的响应时间在 us 量级) ,加之图像本 身的渲染等待时间~5ms(基于 PC 机主流 GPU 水平),4G 下的图像延迟很难达到 20ms 以下。而 5G 的延迟仅 1ms,无论是 LCD 方案或是 OLED 方案,基于现有外 设 GPU图像渲染能力,均可以轻松达到 20ms 以下的图像延迟。5G 的大带宽和低 延迟,将彻底解放 VR 的线缆束缚,甚至可以减轻显示屏和 GPU 的硬件压力,让 VR 成为正真的移动端生产工具。同时,5G 到来也将解放外设主机。VR 设备可以 将大型运算任务交予云端处理。
3. 核心部件国产替代,关注华为产业链投资机会
“缺芯少屏”一直是我国电子工业发展的痛点,特别是“缺芯”方面。贸易战的本 质是芯片的战争。中兴通讯遭受芯片制裁直接致其失去生产主营产品能力。华为通 过 10 年以来的极限生存假设,布局了大量的备胎芯片,在遭遇芯片制裁时不至于 瞬间失去抵抗力。尽管有提前规划和布局,华为芯片制造供应链迁回大陆势在必行。
3.1. 芯片制造全产业链梳理
从目前我国半导体制造各个环节的可替代性来看,芯片设计目前已经可以独立,甚 至在某些领域占据优势;圆晶代工方面,中芯国际 14 nm FinFET 量产,成功进入先 进制程的第二梯队,直逼龙头的 TSMC、三星、Intel;封测代工方面,长电现有技 术不输龙头的台系封测厂。以上的设计和制造代工环节,我国已完全具备国产替代 的能力。在设计和制造外,各个环节上游的材料和核心设备,属于我国半导体制造 的盲区。高分子聚合物复合材料,长期被日本厂商占据,需要常年的追赶,大量的 资金投入以及几代的人才培养,短期内不可能实现国产替代。
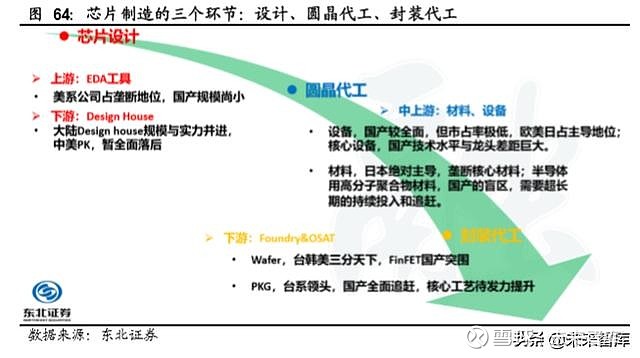
芯片设计:上游被美系公司垄断,下游中美持续 PK
芯片设计上游, 指 EDA工具公司。美系公司占据 EDA工具市场的大头。前三大 EDA 公司均为美系公司:Synopsis、Cadence、Mentor Graphic(已被西门子收购),占据 全球 EDA 市场 80%以上的份额。国系 EDA 软件全球份额不足 5%。国产 EDA 的共 性问题在于材料库不全、对先进工艺了解少、客户基数少、改进慢,需要长期与设 计和制造配合,探索改进方向。
芯片设计下游,指芯片设计公司(Design House/ Fabless)。在第一梯队,我国的华 为海思以及紫光展锐,从营收上已经能够排进全球前十,且设计水平处于业界顶尖。 在第二梯队,我国的设计公司规模尚小,但是均专注于某个领域,发展势头良好, 典型代表有阿里平头哥、汇顶科技、比特大陆、寒武纪等公司。整个芯片设计下游, 中美公司将长期处于进行竞争状态。

圆晶代工:上游材料被日系公司垄断,国产设备在欧美日夹击下寻求突破;下游圆 晶代工厂,中芯国际 14 nm FinFET成功突围,领航大陆圆晶厂直追第一梯队
圆晶代工上游,主要指圆晶工艺的各材料和设备商。在材料方面,该市场主要被日 系公司垄断。以硅片为例,前两大硅片供应商均为日系公司(信越、盛高),合占 据全球 50%以上份额 。影响圆晶制程的核心材料,如光刻胶、显影液等,也基本 以日系公司为主;在设备方面,国产设备基本上已做到全面覆盖制造领域,但市占 率很低,且几乎没有进入圆晶厂的先进制程供应链,仅中微的干法刻蚀机成功打入 TSMC 7nm 制程的供应链。在核心设备方面,如光刻机,我国光刻机与龙头 ASML 的技术差距巨大,还无法实现国产光刻机进行大规模芯片制造。

圆晶代工下游,指圆晶代工厂。从整个市场份额来看,龙头属于 TSMC,占据 50% 以上的市场,其次是三星和格罗方德,大陆龙头圆晶厂中芯国际份额不到 5%。从 技术能力上看,TSMC 和三星具备最先进的制程,即 7nm。格罗方德、intel、联电 处于 10/12/14nm 的第二梯队。大陆的中芯国际在梁孟松加盟后量产 14nm FinFET, 成功进入第二梯队,持续保持对第一梯队的追赶。

封装代工:上游材料,日系公司绝对垄断;下游封装代工厂,大陆已有国产替代的 实力
封装代工上游,指核心的封装材料,如 TIM、Underfill、Molding Compound、RDL (PI、PBO) ,Solder、Solder resist、封装基板 Substrate 以及 Substrate 的构成材料如, Core、ABF、Prepreg 等。核心的封装材料大多属于高分子聚合物类,以热固型的环 氧树脂添加填料构成的复合材料体系。我国在这方面的基础较为薄弱,而日本在高 分子聚合物方面的研究则非常深入。整个核心封装材料的市场,日系公司占据绝对 垄断的地位,特别是封装基板 Substrate 的构成材料,日本全面垄断。在上游材料方 面,我国短期内暂无可能实现替代,高分子领域人才缺口极其严重,需要通过国家 战略,大力发展高分子学科,长期坚持人才培养。

封装代工下游,指 OSAT 封测厂。封测处于芯片制造的最后一环,也是制造门槛相 对低的一环,因此国家在半导体战略上的最初投入也是从封测开始。经过多年来的 投入,大陆封测厂规模已经具备世界级水平,长电科技在收购金科星鹏后,市场份 额排在世界前三。华天科技、通富微电的市场规模也紧随其后。从技术水平上看, 长电已经具备国际龙头封测厂 ASE、SPIL、Amkor 所具备的绝大部分技术能力,在 先进封装方面,长电、华天始终保持第一线的技术水平。但在一些核心技术指标上, 大陆封测厂据龙头的 ASE 还有比较大的差距。总体而言,大陆封测厂已具备国产替 代的技术潜力。

3.2. 大陆圆晶封测制造实力已具备,华为供应链国产替代是历史机遇
中芯国际 14 nm FinFET 打开国产替代的空间
我们认为,中芯国际 14 nm FinFET 量产对高端芯片国产化是一个绝对的利好。
一方面,FinFET 本身的开发非常难,当前世界上仅 6 家公司(TSMC、三星、intel、 格罗方德、联电、中芯国际)可以做到。而中芯国际联合 CEO 梁孟松在加盟后, 历时仅一年半便带领中芯国际成功量产 14nm FinFET,其技术团队的功底不可小觑; 另外,14 nm 是进入 10 nm 乃至 7 nm、5 nm 的门槛,从 14 nm 进入 10 nm 以下的时 间比开发 FinFET 本身要短。随着摩尔定律失效,TSMC、三星、intel 在追逐 5 nm 及以下制程时,中芯国际有望实现制程上的快速追赶。
另一方面,14 nm 刚好位于芯片的高低端制程门槛。除了手机、PC、服务器、AI 等高性能芯片对制程有最高要求外,绝大部分应用场景并不需要最先进的制程。以 华为各产品的芯片制程为例,除了手机(麒麟)、AI(Ascend)、服务器(鲲鹏)芯 片外,几乎所有的芯片制程都在 12 nm 以上,甚至中端的服务器芯片 Kunpeng 916 也没有用最先进的 7 nm,而是用的 16 nm 制程。综上,中芯国际的 14 nm 对于华为 供应链而言,有广阔的替换空间。

圆晶封装趋向垂直一体化,“ 中芯国际——长电”组合潜力巨大
依靠晶圆制程的摩尔定律已经失效,而先进封装成为延续摩尔定律最有效的方式。 先进封装通过多 Die 互联,将不同系统之间的通讯距离缩短,通过提升芯片系统整 体的信息交换速度来提升芯片性能,以及通过缩小 Die 间的间距来实现更多系统的 集成。由于先进封装用到了大量的圆晶光刻工艺,因此龙头的圆晶厂在具备先进光 刻工艺技术的前提下,逐步渗透至封装领域,如 TSMC 推出了 InFO(即 Fanout 封 装)以及 CoWoS(TSV、2.5D 封装)封装技术,开拓了其先进封装领域的业务。而 OSAT 封测厂方面,各家也相应推出了 TSV 和 Fanout 技术,开始涉足圆晶光刻工艺 的业务。圆晶和封装相互渗透,龙头的圆晶厂在光刻工艺上有绝对的技术优势。这 一点从 TSMC 独揽苹果 iPhone 处理器 A系列芯片的圆晶和封装一体化代工业务就 可看出。
中芯国际作为长电的大股东,经历了两年的垂直整合,随着新任长电 CEO 上任, “中 芯国际——长电”组合在管理上的协同效应有望得到加强。从技术水平上,当前长 电已经具备各类先进封装的技术能力。中芯国际在 14 nm 量产后,有望获得更多的 芯片订单。而“中芯国际——长电”组合,在中芯国际完成圆晶代工制造后,通过 对长电订单扶持,将后道封测代工交付与长电,有望让长电获得进一步的增长。
4. 投资标的
4.1. 立讯精密:消费电子、汽车及通讯业务高速增长,运营能力持续增强
4.2. 卓胜微:国内稀缺射频前端芯片企业,受益 5G 和国产替代双逻辑
4.3. 水晶光电:滤光片龙头,受益于摄像头渗透率提升
4.4. 联创电子:玻塑混合龙头企业,受益高像素镜头渗透率提升
4.5. 圣邦股份:模拟芯片和电源管理芯片龙头,国产替代业绩兑现
4.6. 歌尔股份:智能声学整机增长迅速,5G 助力 VR/AR 业务崛起
4.7. 鹏鼎控股:全球PCB 龙头,5G 驱动新一轮成长期
4.8. 生益科技:高频高速覆铜板+PCB 乘 5G 东风高速增长
4.9. 东山精密:5G 基站终端多点布局,步入快速成长期
4.10. 顺络电子:国内电感龙头,5G+汽车电子助力公司腾飞
4.11. 洁美科技:国内纸质载带龙头,行业回升+新产品开辟成长空间
4.12. 三环集团:控成本+重研发,多产品发力
……
(报告来源:东北证券)
获取报告请登陆未来智库www.vzkoo.com。